КОНСПЕКТ ЛЕКЦИЙ
по курсу
«ФИЗИЧЕСКИЕ ОСНОВЫ МИКРОЭЛЕКТРОНИКИ»
специальности 210201
«Проектирование и технология радиоэлектронных средств»
Утверждено на заседании
кафедры ЭИУ1-КФ
28.01.09 протокол № 6
Калуга, 2009 г.
Оглавление
Элементы зонной теории твердых тел
1.1. Электронный газ в периодическом потенциальном поле........... 3
1.2. Зоны Бриллюэна........................................................................... 7
1.3. Эффективная масса электрона..................................................... 8
1.4. Зонная схема кристаллических тел - проводники, диэлектрики, полупроводники........................................................................... 12
Статистика электронов и дырок в полупроводниках
2.1. Собственные и примесные полупроводники............................... 15
2.2. Зависимость концентрации свободных носителей в полупроводнике от положения уровня Ферми............................................... 17
2.3. Уровень Ферми и равновесная концентрация носителей в невырожденных собственных полупроводниках.................................... 20
2.4. Положение уровня Ферми и концентрация носителей в примесных полупроводниках.................................................................. 21
2.5. Неравновесные носители. Рекомбинация носителей................... 24
2.6. Поверхностная рекомбинация………………………………………27
2.7. Уравнение неприрывности………………………………………….27
Электропроводность твердых тел
3.1. Движение электронов под действием внешнего поля................. 30
3.2. Зависимость подвижности носителей заряда от температуры... 31
3.3. Электропроводность чистых металлов....................................... 32
3.4. Электропроводность собственных полупроводников................ 34
3.5. Электропроводность примесных полупроводников.................. 36
3.6. Диффузионные уравнения........................................................... 37
Контактные явления
4.1. Контакт электронного и дырочного полупроводников............. 40
4.2. Равновесное состояние p – n – перехода..................................... 42
4.3. Зонная диаграмма p – n – перехода при положении внешнего поля............................................................................................... 45
4.4. ВАХ тонкого p – n – перехода.................................................... 47
Поверхностные явления
5.1. Поверхностные состояния…………………………………….…….52
5.2. Эффект поля. МДП – структура.................................................. 52
5.3. Вольт – фарадная характеристика.............................................. 53
Полевые транзисторы
6.1. Общие сведения............................................................................ 57
6.2. Полевые транзисторы с изолированным затвором.................... 57
6.3. Статические характеристики МДП – транзисторов................... 59
6.4. Основные параметры МДП – транзисторов............................... 61
6.5. Полевые транзисторы с управляющим p – n – переходом........ 62
Электрофизические свойства p- n-переходов и структур
металл-диэлектрик-полупроводник
7.1. Барьерная и диффузионная емкость p-n-перехода……………….. 65
7.2. Механизмы пробоя p-n-переходов………………………………… 66
7.3. Механизмы переноса заряда через тонкие диэлектрические
пленки…………………………………………………………………69
Литература…………………………………………………………. .73
Приложение 1 Элементы квантовой механики и физической
статистики…………………………………………………………… 74
Приложение 2 Фазовая и групповая скорости, фононы………….. 87
Элементы зонной теории твердых тел
Зоны Бриллюэна
Ранее использовалось понятие пространства импульсов, которое определялось путем задания составляющих импульсов в декартовой системе координат. Модуль волнового вектора или волновое число равно k=  , а
, а  - длина волны де Бройля.
- длина волны де Бройля.
Тогда p=  k, если нет
k, если нет  , то
, то  , где
, где  =
=  . (1.2.1)
. (1.2.1)
Следовательно, импульс пропорционален волновому вектору k p=  k, тогда вместо пространства импульсов можно рассматривать k - пространство, задаваемое составляющими kx ky kz. Разрешенным энергетическим зонам в твердом теле соответствуют зоны в k пространстве. Области значений волнового вектора k, в пределах которых энергия электрона E(k), являющаяся периодической функцией k, испытывает полный цикл своего изменения, называют зонами Бриллюэна. На границах зон энергия претерпевает разрыв. Для одномерного кристалла первая зона Бриллюэна простирается от k= -p/a до k= p/a и имеет протяженность 2p/a (см. рис. 1.6).
k, тогда вместо пространства импульсов можно рассматривать k - пространство, задаваемое составляющими kx ky kz. Разрешенным энергетическим зонам в твердом теле соответствуют зоны в k пространстве. Области значений волнового вектора k, в пределах которых энергия электрона E(k), являющаяся периодической функцией k, испытывает полный цикл своего изменения, называют зонами Бриллюэна. На границах зон энергия претерпевает разрыв. Для одномерного кристалла первая зона Бриллюэна простирается от k= -p/a до k= p/a и имеет протяженность 2p/a (см. рис. 1.6).
Как уже указывалось, из решения уравнения Шредингера для электрона, находящегося в периодическом потенциальном поле кристаллической решетки, следует, что собственные значения (разрешенные) энергии электрона должны быть периодическими функциями  .
.
 (1.2.2)
(1.2.2)
Кривая E(kx)называется дисперсионной кривой. Как видно из рисунка 1.7, для каждой из разрешенной зон справедливо соотношение (1.2.2), хотя кривые E(kx)для разрешенных зон отличаются друг от друга. С ростом Е ширина разрешенных зон увеличивается. Если отрезок CD сдвинуть на 2p/ax влево, а отрезок C1D1 на 2p/ax вправо, то вторую зону Бриллюэна можно привести к первой. Первую зону Бриллюэна, куда перенесены E(kx) для разных энергетических зон называют приведенной зоной Бриллюэна (рис. 1.8.). В дальнейшем будут преимущественно рассматриваться лишь две верхние разрешенные энергетические зоны. Верхняя разрешенная зона называется зоной проводимости, а нижняя валентной зоной.
В реальных кристаллах направления составляющих волнового вектора k выбирают в соответствии с определенными кристаллографическими направлениями. Зависимости E(k) у реальных кристаллов являются достаточно сложными.
В качестве примера рассмотрим зонную структуру кремния для двух направлений в k пространстве. Минимум зависимости E(k) или дисперсионной кривой называют дном энергетической зоны, а максимум потолком зоны. Как видно из рисунка (1.9) дно зоны проводимости у кремния находится не в середине зоны Бриллюэна, а вблизи ее границы в направлении [100]. Вершина валентной зоны расположена в середине зоны Бриллюэна.
Минимальный зазор между валентной зоной и зоной проводимости принимается за ширину запрещенной зоны Eg.
При упрощенном рассмотрении энергетической структуры полупроводников вместо истинных дисперсионных кривых, E(k) ограничивающих валентную зону и зону проводимости, проводят две параллельные прямые: одну касательную к дну зоны проводимости, вторую касательную к вершине валентной зоны. Первую прямую принимают за нижнюю границу (дно) зоны проводимости, вторую за верхнюю границу (потолок) валентной зоны.
Эффективная масса электрона
Известно:
 , (1.3.1)
, (1.3.1)
 . (1.3.2)
. (1.3.2)
Кинетическая энергия свободного электрона равна Ek=E
 . (1.3.3)
. (1.3.3)
Подставим (1.3.2)
тогда  (1.3.4)
(1.3.4)

| |||||||||||||
| |||||||||||||
| |||||||||||||
| |||||||||||||
| |||||||||||||
| |||||||||||||
 | |||||||||||||
Рис. 1.6
 | |||||
| |||||
| |||||
|
|
|
|
|
|
|
|
|

Рис. 1.7

| |||||
 | |||||
| |||||
Рис. 1.8
|
|
|
|
|
|
|
|
|
|

Рис. 1.9
Продифференцируем Ek по k:
 , (1.3.5 )
, (1.3.5 )
отсюда  . (1.3.6)
. (1.3.6)
Подставим (1.3.6) в (1.3.2)
 . (1.3.6)
. (1.3.6)
Формула (1.3.6) справедлива не только для свободного электрона, но и для электрона, находящегося в потенциальном поле.
Пусть энергия зонного электрона изменяется под некоторым внешним воздействии.
dE=FVdt . (1.3.7)
где F - внешняя сила
Подставим (1.3.6) в (1.3.7)
 , (1.3.8)
, (1.3.8)
отсюда  . (1.3.9)
. (1.3.9)
Продифференцируем (1.3.6) по времени
 . (1.3.10)
. (1.3.10)
Подставим (1.3.9) в (1.3.10)
 . (1.3.11)
. (1.3.11)
где а - ускорение.
Формула (1.3.11) связывает ускорение и силу, т.е. она выражает второй закон Ньютона F=ma; a=F/m.
Из (1.3.11) следует, что под действием внешней силы электрон в периодическом поле кристалла движется так, как двигался бы свободный электрон, обладающий массой
 . (1.3.12)
. (1.3.12)
Масса m* называется эффективной массой электрона. Приписывая электрону, находящемуся в периодическом поле кристалла массу m*, мы можем считать этот электрон свободным и описывать его движение во внешнем поле так, как описывается движение свободного электрона. Эффективная масса, отражающая особенности движения электрона в периодическом поле, является своеобразной функцией. Она может быть как положительной, так и отрицательной, а по абсолютному значению как меньше, так и больше массы покоя электрона. Эффективная масса свободного электрона равна массе покоя.
При движении электрона в периодическом потенциальном поле кристалла работа внешней силы может переходить как в кинетическую, так и потенциальную энергию электрона.
 . (1.3.13)
. (1.3.13)
Если часть работы внешней силы F=-qe переходит в потенциальную энергию, то скорость электрона возрастает медленнее, чем у свободного электрона и следовательно его эффективная масс больше массы покоя. Если вся работа внешней силы переходит в потенциальную энергию, то скорость электрона изменяться не будет, и он будет вести себя, как частица с бесконечно большой массой.
В потенциальную энергию может переходить не только работа внешней силы, но и кинетическая энергия электрона. Скорость электрона будет в этом случае уменьшаться, т.е. он ведет себя как частица с отрицательной массой.
Возможен случай, когда в кинетическую энергию может переходить не только работа внешней силы, но и потенциальная энергия, тогда скорость электрона будет расти быстрее, чем у свободного, т.е. его эффективная масса будет меньше массы покоя. На рис. 1.10 показаны зависимости E, V, m* от волнового вектора k. Вблизи дна разрешенной зоны энергия m* электрона положительна, а у потолка зоны отрицательна. Точка А - точка перегиба зависимости E(k), в этой точке  достигает максимума, а вторая производная
достигает максимума, а вторая производная  равна 0, а m*®¥. Поскольку k вектор, то m* зависит от направления движения электрона в кристалле.
равна 0, а m*®¥. Поскольку k вектор, то m* зависит от направления движения электрона в кристалле.
В примесных полупроводниках
Положение уровня Ферми в примесных полупроводниках в отличие от собственных существенным образом зависит от температуры.
Область нижних температур. При низких температурах энергия тепловых колебаний решетки значительно меньше ширины запрещенной зоны. Поэтому эти колебания не могут обеспечить переброс электронов из валентной зоны в зону проводимости. Однако, этой энергии оказывается достаточно для переброса электронов с донорных уровней в зону проводимости, а дырок с акцепторных уровней в валентную зону, т.к. для осуществления этих процессов нужна энергия на два порядка меньше, чем Eg. Следовательно, в области низких температур в примесных полупроводниках происходит возбуждение лишь “примесных” носителей заряда: электронов в электронных полупроводниках и дырок в дырочных полупроводниках.
Показано, что положение уровня Ферми в этой области температур определяется соотношением
 , (2.4.1)
, (2.4.1)
для электронного полупроводника и соотношением
 , (2.4.2)
, (2.4.2)
для дырочного полупроводника.
ND и NA - концентрация соответственно донорной и акцепторной примесей.
На рисунках 2.5 а и b показано изменение положения уровня Ферми с повышением температуры в примесных полупроводниках n- и p-типа соответственно.
Подставляя в (2.2.4) и (2.2.5) полученные выражения для положения уровня Ферми в примесных полупроводниках соответственно получаем.
 , (2.4.3)
, (2.4.3)
 . (2.4.4)
. (2.4.4)
Выражения (2.4.3) и (2.4.4) определяют концентрацию электронов в электронном полупроводнике и дырок в дырочном полупроводнике.
Область истощения примесей. С увеличением температуры концентрация электронов в зоне проводимости увеличивается, а концентрация электронов на донорных уровнях уменьшается, т.к. донорные уровни постепенно истощаются. Аналогично себя ведут и акцепторные уровни в дырочных полупроводниках.
При полном истощении примесей концентрация электронов в зоне проводимости у полупроводника n-типа становится практически равной концентрации донорной примеси ND. Количеством электронов перешедших из валентной зоны при этих температурах можно пренебречь.
 . (2.4.5)
. (2.4.5)
Аналогично для дырок
 . (2.4.6)
. (2.4.6)
Температура, при которой происходит полное истощение примесей TИ тем выше, чем больше энергия ионизации примеси  и
и  (Для Ge Ea=0,01 эВ, TИ»30K)
(Для Ge Ea=0,01 эВ, TИ»30K)
Область высоких температур. При дальнейшем повышении температуры начинается термическое возбуждение собственных носителей, в электронном полупроводнике все большее число электронов переходит из валентной зоны в зону проводимости. До тех пор пока концентрация собственных носителей (электронов пришедших в зону проводимости из валентной зоны) остается меньше ND (ni<<ND), суммарная концентрация электронов в зоне проводимости сохраняется практически постоянной и раной ND. Однако, с повышением температуры ni - концентрация собственных носителей увеличивается и может не только достичь величины ND, но и значительно превзойти ее. При этом полупроводник все более приближается к состоянию собственного полупроводника (ni=pi), вследствие чего уровень Ферми приближается к положению уровня Ферми в собственном полупроводнике. При ni>>ND n=ni+ND»ni. Это соответствует переходу к собственной проводимости полупроводника. Температура, при которой осуществляется переход к собственной проводимости полупроводника ТC тем выше, чем больше ширина запрещенной зоны полупроводника и концентрация примеси в нем.
При температуре T>TC уровень Ферми в примесном полупроводнике совпадает с уровнем Ферми в собственном полупроводнике.
На рис. 2.6 показаны качественные кривые зависимости логарифма концентрации электронов в зоне проводимости в n-полупроводнике от обратной температуры при различных концентрациях примеси. На кривой можно выделить три участка: I-участок , соответствующий примесной проводимости полупроводника, II-участок, соответствующий области истощения примеси, III- участок собственной проводимости полупроводника. У полупроводников с высокой концентрацией примеси участок истощения примеси отсутствует (см. кривую ND4).
Как уже отмечалось, в собственных полупроводниках проводимость осуществляется электронами зоны проводимости и дырками валентной зоны. В примесных же полупроводниках проводимость обусловлена в основном носителями одного типа: в n-полупроводниках - электронами зоны проводимости, т.к. их концентрация значительно превышает концентрацию дырок, а в р-полупроводниках дырками.
|
|
|
|
|
|
|
|
|
|
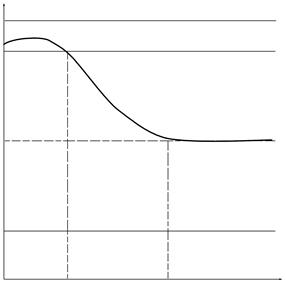

| ||||||||||||||||||
| ||||||||||||||||||
| ||||||||||||||||||
| ||||||||||||||||||
| ||||||||||||||||||
| ||||||||||||||||||
| ||||||||||||||||||
| ||||||||||||||||||
|
| |||||||||||||||||
Рис. 2.5
|
|
|
|
|
|
|
|
|
|
|
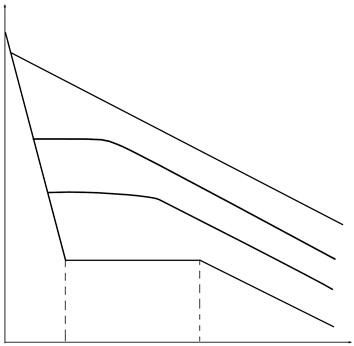
|
Рис. 2.6
Электроны в n-полупроводнике и дырки в р-полупроводнике называют основными носителями заряда. Наряду с основными носителями в примесных полупроводниках содержатся неосновные носители заряда это дырки - в n-полупроводниках и электроны в р-полупроводнике.
Основные носители обозначают nno, ppo и неосновные npo, pno. Таким образом в n-полупроводнике концентрация электронов nno, а концентрация дырок pno.
В том случае закон действующих масс можно записать в виде
 для n-полупроводника,
для n-полупроводника,
(2.4.7)
 для р-полупроводника.
для р-полупроводника.
Из (2.4.7) следует, что легируя полупроводник примесью, мы повышаем концентрацию основных носителей, что приводит к понижению концентрации неосновных носителей, т.к. их произведение должно оставаться неизменным.
Поверхностная рекомбинация
Процессы рекомбинации в приповерхностном слое полупроводника и в объеме полупроводника в принципе не отличаются. Однако поскольку на поверхности полупроводника имеются добавочные поверхностные уровни, то возможности рекомбинации носителей на поверхности увеличиваются по сравнению с объемом. Так как активные области полупроводниковых приборов ИМС расположены вблизи поверхности полупроводника, то влияние поверхности необходимо учитывать при их проектировании и анализе работы.
Обозначим поверхностное время жизни носителей через tS, а объемное через tV. Если рабочий участок полупроводникового прибора расположен частично в объеме и частично в приповерхностном слое используют эффективное время жизни носителей t, которое определяется из выражения:
1/t=(1/ts+1/tv). (2.6.1)
Поскольку ts<tv, то эффективное время жизни ближе к ts.
Так как поверхностное время жизни трудно определить экспериментально или рассчитать, то для характеристики поверхностной рекомбинации используется параметр s – скорость поверхностной рекомбинации, который впервые был введен Шокли.
Скорость поверхностной рекомбинации представляет собой коэффициент, определяющий скорость потока носителей заряда к поверхности. Направленные потоки носителей из объема к поверхности полупроводника возникают вследствие более высокой интенсивности рекомбинации у поверхности.
Jn=q×s×Dn, (2.6.2)
Jр=q×s×Dр, (2.6.3)
где Jn и Jр плотности тока электронов и дырок, текущего к поверхности полупроводника.
Данные токи являются паразитными, и их следует уменьшать, уменьшая скорость поверхностной рекомбинации всеми возможными средствами. Скорость поверх6ностной рекомбинации существенно зависит от способа и качества обработки кристалла и ее величина лежит в пределах от 100 до 104 см/с.
Уравнение непрерывности
Рассмотрим локальный объем полупроводника с одиночной площадью S=1 см2 и толщиной dx. Объем такой области будет равен V=S·dx=dx рис. 2.8. Пусть n(x,t) – концентрация электронов в этой области. Общее количество электронов в этой области будет равно n(x,t)dx. Изменение количества электронов в этой локальной области за время dt будет равно:
 . (2.7.1)
. (2.7.1)

Рис. 2.8
Изменение количества электронов может происходить вследствие действия следующих процессов:
- термической генерации nG=G×dt×dx – где G – скорость генерации;
- рекомбинации носителей nR=-R×dt×dx;
- разностью входящего и выходящего потоков электронов в локальную область и из нее под действием электрического поля и градиента концентрации:
 . (2.7.2)
. (2.7.2)
Общее изменение концентрации электронов будет равно:
 , (2.7.3)
, (2.7.3)
тогда
 . (2.7.4)
. (2.7.4)
Плотность тока электронов равна jn=-fnq, следовательно, fn=-  .
.
Тогда  . (2.7.5)
. (2.7.5)
Это выражение называется уравнением непрерывности. Плотность тока jn в общем случае складывается из дрейфовой и диффузионных составляющих.
Пусть jn=0, тогда  .
.
В равновесном состоянии G=R  .
.
В неравновесном состоянии G ≠ R.
Обозначим G-R=  , где Δn(t) избыточная концентрация электронов, являющаяся функцией времени. Подставив в (2.7.5) получим:
, где Δn(t) избыточная концентрация электронов, являющаяся функцией времени. Подставив в (2.7.5) получим:

Решение этого уравнения будет иметь вид  ,
,
где Δn(0) – избыточная концентрация в начальный момент времени.
Величину τn называют временем жизни носителей, в данном случае электронов. Это среднее время, в течение которого избыточная концентрация уменьшается в е раз вследствие рекомбинации.
Температуры
Рассеяние электронов и дырок проводимости может происходить на ионах и нейтральных атомах примеси, дефектах структуры, границах кристалла, тепловых колебаниях решетки.
В области высоких температур основное значение имеет рассеяние электронов на тепловых колебаниях решетки. Установлено, что в области высоких температур, в которой основное значение имеет рассеяние на фотонах, т.е. на тепловых колебаниях решетки, подвижность невырожденного газа пропорциональна температуре в степени –3/2
 . (3.2.1)
. (3.2.1)
Подвижность же носителей вырожденного газа обратно пропорциональна температуре
 . (3.2.2)
. (3.2.2)
В области низких температур основное значение имеет рассеяние на ионизированных примесных атомах. Ионы примеси отклоняют электроны, проходящие вблизи них, и тем самым уменьшают скорость их движения в первоначальном направлении.
Показано, что подвижность носителей заряда в области низких температур, обусловленная рассеянием на ионизированных примесях, пропорциональна T3/2 для проводников с невырожденным газом и не зависит от Т для проводников с вырожденным газом.
У чистых металлов, у которых концентрация примеси очень мала и при низких температурах основным механизмом рассеяния остается рассеяние на колебаниях кристаллической решетки. Поэтому подвижность вырожденного электронного газа в этих металлах пропорциональна T-5.
Диффузионные уравнения
Пусть вдоль полупроводника имеется градиент концентрации свободных носителей заряда, создание которого возможно с помощью освещения образца, его неравномерного нагрева и т.д.
В общем случае, ток проводимости состоит из геометрической суммы дрейфового и диффузионного токов.
Дрейфовые составляющие плотности тока проводимости определяются по закону Ома.
 , (3.6.1)
, (3.6.1)
 , (3.6.2)
, (3.6.2)
где  - электрический потенциал, n и р концентрации электронов и дырок, которые в общем случае не являются равновесными.
- электрический потенциал, n и р концентрации электронов и дырок, которые в общем случае не являются равновесными.
Диффузионная составляющая тока зависит от градиента концентрации свободных носителей заряда
 , (3.6.3)
, (3.6.3)
 . (3.6.4)
. (3.6.4)
Диффузионный ток создает объемные заряды, поле которых вместе с внешним полем обуславливает дрейфовый ток.
В представленном на рисунке 3.4 случае, когда p1>p2, левая часть будет заряжаться отрицательно, а правая положительно и внутреннее электрическое поле полупроводника, обусловленное объемными зарядами, направлено против внешнего поля.
В общем случае, ток носителей одного вида в полупроводнике равен сумме диффузионного и дрейфового тока:
 , (3.6.5)
, (3.6.5)
 . (3.6.6)
. (3.6.6)
Если рассматривать токи в каком либо одном направлении, то уравнения (3.6.5), (3.6.6) можно переписать в виде
 , (3.6.7)
, (3.6.7)
 . (3.6.8)
. (3.6.8)
Полная плотность тока равна:

 . (3.6.9)
. (3.6.9)
Направления токов определяют обычно в зависимости от направления градиентов потенциала j и концентраций. Знаки токов учитывают при записи уравнений.
Связь между дрейфовой подвижностью носителей и коэффициентами диффузии выражается с помощью уравнений Эйнштейна
|
|
|
|

|
Рис. 3.5
|
|
|
|
|
|

Рис. 4.1
 ,
,  . (3.6.10)
. (3.6.10)
Подвижность носителей пропорциональна коэффициенту диффузии.
Контактные явления
ВАХ тонкого р- n -перехода
Тонким р-n переходом называют электронно-дырочный переход, толщина которого столь мала, что можно пренебречь процессами рекомбинации и генерации носителей заряда в области объемного заряда р-n-перехода.
Т.е. если известна плотность потока дырок jp или электронов jn в каком-либо сечении р-n-перехода, то она такова же в любом другом сечении р-n-перехода.
Из формул (4.2.4) и (4.2.5) можно записать концентрацию электронов npгр на границе запирающего слоя в р-области и концентрацию дырок pnгр на границе запирающего слоя в n-области:
 , (4.4.1)
, (4.4.1)
 . (4.4.2)
. (4.4.2)
При этом Eip и Ein принимают значения соответствующие границам.
Для неосновных носителей заряда вдали от р-n перехода можно записать
 , (4.4.3)
, (4.4.3)
 . (4.4.4)
. (4.4.4)
В формулах (4.4.3) и (4.4.4) произошла замена квазиуровней по сравнению с формулами (4.4.1), (4.4.2), т.к. в электронейтральной части полупроводника вдали от р-n-перехода в р-области EFp=EFn, а в n-области EFn=EFp.
Разделим левые и правые части выражений (4.4.1) и (4.4.2) друг на друга:
 ,
,
откуда
 . (4.4.5)
. (4.4.5)
Разделим левые и правые части выражений (4.4.3) и (4.2.4) друг на друга:
 ,
,
откуда
 . (4.4.6)
. (4.4.6)
При EФn-EФp>0, т.е. при прямом включении р-n-перехода: npгр>npo pnгр>pno.
Избыточная концентрация неосновных носителей заряда на границах в этом случае равна:
 , (4.4.7)
, (4.4.7)
 . (4.4.8)
. (4.4.8)
Эта избыточная концентрация появляется вследствие инжекции носителей заряда через р-n-переход. Dn и Dp являются функциями 
 . На рис. 4.9. показано изменение избыточной концентрации неосновных носителей от расстояния от области р-n-перехода.
. На рис. 4.9. показано изменение избыточной концентрации неосновных носителей от расстояния от области р-n-перехода.
Электроны, инжектированные в р-область, притягивают к себе дырки из объема этой области, так что вне р-n-перехода сохраняется электронейтральность. Недостаток носителей заряда в объеме пополняется через контакт. Аналогично дырки, инжектированные в n-область, притягивают к себе электроны из объема этой области, где также сохраняется электронейтральность. Глубина проникновения инжектированных носителей определяется их рекомбинацией. Неосновные носители рекомбинируют с основными, поэтому концентрация неосновных носителей падает с расстоянием и равна:
 , (4.4.9)
, (4.4.9)
 . (4.4.10)
. (4.4.10)
где Ln,Lp- расстояние от границы р-n-перехода, на котором концентрации неосновных носителей уменьшаются в е раз, которое называется диффузионной длиной. Заметим, что при приложении прямого смещения запирающий слой сужается. При обратном смещении р-n-перехода он расширяется и: EFn-EFp=qU<0.
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|

Рис. 4.9
|
|
|
|

Рис. 4.10
Тогда для обратного включения npгр<npo. В этом случае наблюдается проникновение неосновных носителей заряда через р-n-переход из областей прилегания к р-n переходу. Выражения (4.4.7-4.4.10) сохраняются и в этом случае. Однако, избыточная концентрация здесь имеет отрицательный знак  , т.е. в этом случае мы имеем дело не с избыточной, а с недостаточной концентрацией неосновных носителей.
, т.е. в этом случае мы имеем дело не с избыточной, а с недостаточной концентрацией неосновных носителей.
p-n переход можно считать тонким, если d<Ln и d<Lp, т.е. если толщина перехода меньше диффузионных длин носителей заряда.
Плотность диффузионного тока через границы при любой полярности внешнего напряжения равна:
 , (4.4.11)
, (4.4.11)
 . (4.4.12)
. (4.4.12)
Подставим в (4.4.11) и (4.4.12) выражения (4.4.9) и (4.4.10) и получим с учетом (4.4.7) и (4.4.8)
 , (4.4.13)
, (4.4.13)
 . (4.4.14)
. (4.4.14)
Поскольку мы предположили, что плотности электронов и дырок одинаковы в любом сечении р-n-перехода и на его границах, а так же поскольку движение электронов и дырок противоположно друг другу, ВАХ р-n-перехода можно представить в виде:
 , (4.4.15)
, (4.4.15)
С учетом того, что:
 , (4.4.16)
, (4.4.16)
 , (4.4.17)
, (4.4.17)
 . (4.4.18)
. (4.4.18)
Проанализируем (4.4.15).
При обратном смещении на р-n-переходе (U<0)  , а скобка
, а скобка  , следовательно, обратный ток р-n-перехода стремится к
, следовательно, обратный ток р-n-перехода стремится к
 . (4.4.19)
. (4.4.19)
Эту плотность тока называют плотностью тока насыщения. Она достигается уже при U»-0,1В. jн определяется концентрацией неосновных носителей и у германиевых р-n-переходов больше, чем у кремниевых.
При прямых смещениях плотность тока через р-n-переход растет по экспоненте и уже при небольших напряжениях достигает большого значения.
Подставляя в (4.4.19), (4.4.18) получим
 . (4.4.18)
. (4.4.18)
На рис. 4.10 показана ВАХ р-n-перехода. Как видно из рисунка р-n-переход обладает ярко выраженной односторонней (униполярной) проводимостью, т.е. проявляет высокие выпрямляющие свойства.
Подчеркнем, что перенос заряда через р-n-переход осуществляется с помощью неосновных носителей, т.к. область р-n-перехода обеднена основными носителями.
Поверхностные явлении
Поверхностные состояния
Рассмотрим процессы на поверхности полупроводника. В 1932 г. советским ученым Таммом было показано, что обрыв решетки приводит к возникновению разрешенных уровней в запрещенной зоне. Уровни Тамма возможны для идеальной поверхности полупроводника. Реальные поверхности покрыты слоем адсорбированных атомов и молекул. Эти примеси также создают поверхностные уровни, которые могут быть как донорными, так и акцепторными. Роль примесей могут играть и различные дефекты решетки. Разрешенные уровни в запрещенной зоне полупроводника на его поверхности называются поверхностными уровнями или поверхностными состояниями.
При высокой плотности поверхностных состояний они, взаимодействуя друг с другом, могут размыться в поверхностную зону. Электроны в этой зоне могут двигаться только вдоль поверхности.
Поверхностные состояния могут захватывать электроны или наоборот отдавать их, заряжаясь положительно или отрицательно. Заряжение поверхности полупроводника при заполнении поверхностных состояний сопровождается возникновением у поверхности слоя объемного заряда, нейтрализующего поверхностный заряд. Нейтрализация происходит путем притяжения к поверхности носителей со знаком заряда противоположным знаку заряда поверхности и отталкивания носителей одного знака. Вследствие этого поверхностный слой обедняется носителями того знака, которым заряжена поверхность и обогащается носителями противоположного знака. При этом наблюдается изгиб зон и возникает поверхностный объемный заряд. Если поверхность полупроводника заряжена отрицательно, то в приповерхностном слое зоны изгибаются вверх, а если положительно то низ.
Эффект поля. МДП-структуры
Измерять объемный поверхностный заряд полупроводника можно с помощью поля, перпендикулярного поверхности. Для создания такого поля в полупроводнике, как правило, используют МДП-структуры (рис. 5.1).
Если к идеальной МДП-структуре прикладывается положительное или отрицательное напряжение, то в приповерхностной области полупроводника могут возникнуть три состояния: обеднение, инверсия и обогащение этой области носителями заряда.
Обедненная основными носителями область появляется в случае, когда на металлический электрод подается потенциал, по знаку совпадающий с основными носителями заряда (рис. 5.1, а и б). Вызванный таким потенциалом изгиб зон приводит к увеличению расстояния от уровня Ферми до дна зоны проводимости в полупроводнике n-типа и до потолка валентной зоны в полупроводнике p-типа. Увеличения этого расстояния сопровождается обеднением приповерхностной области основными носителями.
Когда на металлический электрод подается достаточно большой потенциал по знаку совпадающий с основными носителями (рис. 5.2, в и г), то расстояние от уровня Ферми до потолка валентной зоны в полупроводнике n-типа оказывается меньше расстояния до дна зоны проводимости (рис. 5.2, г), вследствие чего концентрация не основных носителей заряда (дырок) у поверхности полупроводника становится выше концентрации основных носителей и тип проводимости этой области меняется. Изменение типа проводимости полупроводника называется инверсией, а слои, в которых оно наблюдается, называются инверсионными слоями.
Если знак потенциала металлического электрода противоположен знаку заряда основных носителей тока в полупроводнике, то происходит притяжение основных носителей к поверхности и обогащение ими приповерхностного слоя (рис. 5.2, д и е).
С изменением концентрации основных носителей под действием внешнего поля в приповерхностном слое меняется и проводимость. Явление изменения поверхностной проводимости под действием поперечного поля называется эффектом поля.
Полевые транзисторы
Общие сведения
Основные принципы работы полевого транзистора были разработаны Лилиенфельдом и Хейлом в начале 30х годов. Первый МДП-транзистор был изготовлен Кангом и Аталлой в 1960 г. Полевой транзистор с управляющим p-n-переходом был разработан Шокли в 1952 г. и изготовлен Дейки и Россом в 1953 г. Полевые транзисторы с диодом Шотки впервые были изготовлены на основе арсенида галлия в 1967 г.
Полевые транзисторы содержат три полупроводниковые области исток, сток и канал, а так же управляющий электрод затвор. Исток и сток сильно легированные области полупроводника.
По структуре и способу управления проводимостью канала различают три типа полевых транзисторов:
- полевые транзисторы с изолированным затвором, между металлическим затвором и каналом расположен слой диэлектрика (МДП-транзисторы);
- полевые транзисторы с управляющим переходом металл-полупро-водник (с диодом Шоттки), металлический электрод затвора образует выпрямляющий контакт с каналом, на который в рабочем режиме подается обратное напряжение;
- полевые транзисторы с управляющем p-n-переходом, в качестве затвора используют слой полупроводника образующий с каналом p-n-переход, в рабочем режиме имеющий обратное включение
Полевые транзисторы по типу проводимости канала подразделяются на транзисторы с каналом n или p -типа.
Если канал n-типа, то рабочими носителями являются электроны и на сток подается положительный потенциал. В случае канала p-типа рабочими носителями являются дырки и на сток подается отрицательный потенциал.
В полевых транзисторах используется движение носителей заряда одного знака, которые под действием электрического поля, созданного вдоль канала, перемещаются от истока к стоку.
Характерной особенностью полевых транзисторов является малый ток затвора. Входное сопротивление полевых транзисторов на постоянном токе составляет 108 ¸1010 Ом. Поэтому полевые транзисторы являются приборами, управляемыми напряжением, в отличие от биполярных транзисторов, которые управляются током.
Статические характеристики
МДП-транзисторов
Выходные характеристики МДП-транзисторов показаны на рисунке 6.6. На выходные ВАХ существенное влияние оказывают изменения в структуре канала, возникающие с ростом напряжения на стоке.
При UИ=UС=0 электрическое поле в диэлектрике и полупроводнике будет однородным, и толщина канала будет одинаковой от истока до стока.
Если напряжение UСИ>0 и не очень велико, то канал ведет себя как обычное сопротивление. Ток стока увеличивается пропорционально напряжению стока. Эту область ВАХ называют линейной областью работы транзистора.
С ростом напряжения UСИ будут увеличиваться ток стока и потенциал поверхности полупроводника в направлении от истока к стоку. Вследствие этого разность потенциалов между затвором и поверхностью полупроводника будет уменьшаться в направлении к стоку. Соответственно сечение канала начинает сужаться в направлении к стоку. При напряжении на стоке равном напряжению насыщения UСН разность потенциалов между затвором и поверхностью полупроводника становится равной нулю у стока. Толщина канала у стока становится равной нулю. МДП-транзистор переходит в режим отсечки канала. При напряжении UСИ>UСН точка отсечки сдвигается к истоку и происходит укорочение канала на DL (рис. 6.7). На участке DL обедненный слой выходит на поверхность полупроводника.
После отсечки канала ток стока перестает зависеть от потенциала стока. Эта область ВАХ называется областью насыщения тока стока.
 |
 |
На острие канала, в точке его перекрытия концентрируется электрическое поле, напряженность которого становится выше критической и наступает режим насыщения скорости дрейфа электронов, инжектированных из острия канала в обедненный слой.
Ток равен: jn=еmnnEKP,
так как vДР=mnEКР=const n=const,
то и jn=const.
P-n-переходом
Структура такого транзистора показана на рис. 6.8. На подложке p-типа формируется эпитаксиальный n-слой, в котором методами диффузии создаются области истока, стока n+ -типа и затвора p+-типа. Управляющий p-n-переход образуют области p+ и n. Токопроводящим каналом является эпитаксиальный слой n-типа расположенный между затвором и подложкой. При работе транзистора управляючий p-n-переход должен быть включен в обратном направлении.
Глубина обедненного слоя управляющего p-n-перехода тем больше, чем больше обратное напряжение на затворе. Толщина канала будет также соответственно меньше. Следовательно с изменением обратного напряжения будет меняться поперечное сечение канала, а следовательно и его сопротивление. При наличии напряжения между стоком и истоком изменяя обратное напряжение на затворе можно управлять выходным током транзистора.
Входным током транзистора является обратный ток p-n-перехода, составляющий для кремниевых приборов 10-9-10-11 А.
На сток транзистора подается положительное напряжение. P-n-переход между эпитаксиальным n-слоем и подложкой включается в обратном направлении, поэтому к подложке прикладывается отрицательное относительно истока напряжение. Иногда подложка используется в качестве второго затвора. В некоторых транзисторах подложка соединяется с затвором и не имеет отдельного вывода.
Статические выходные и передаточные характеристики полевых транзисторов с управляющим p-n-переходом показаны на рис. 6.9 и 6.10.
Выходные характеристики имеют участок насыщения тока, связанный как и у МДП-транзисторов с образованием "горловины" канала вблизи стока.
Напряжением отсечки полевого транзистора с управляющим p-n-переходом называется напряжение на затворе, при котором практически полностью перекрывается канал и ток стока стремится к нулю.
 |
Диэлектрические пленки
Основными механизмами переноса заряда, определяющими проводимость изолирующих пленок являются: термополевая эмиссия Шоттки, эмиссия Пула-Френкеля и сильнополевая туннельная инжекция по Фаулеру-Норугейму.
Термополевая эмиссия по Шоттки. Термоэлектронная эмиссия электронов объясняется наличием высокоэнергетического «хвоста» в распределении электронов по энергии.
Термоэлектронная эмиссия – это испускание электронов нагретым телом в вакууме (рис.7.5).
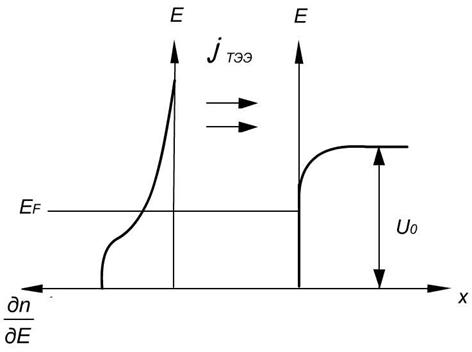
Рис. 7.5
При наложении внешнего электрического поля происходит понижение потенциального барьера, разделяющего металл и диэлектрик. Это явление называется эффектом Шоттки.
Снижение потенциального барьера происходит в результате сложения потенциала внешнего поля uε=qεx с потенциалом u0 на границе металл-диэлектрик, определяемым силами зеркального изображения (рис.7.6).
Термополевая эмиссия Шоттки представляет собой надбарьерную термоэлектронную эмиссию, облегченную за счет наложения внешнего электрического поля. Эмиссия Шоттки является одним их основных механизмов переноса зарядов в системах металл-диэлектрик-металл и металл-полупроводник-металл.

Рис. 7.6
Плотность тока эмиссии по Шоттки равна:
 ,
,
где А=12∙105А /см2∙град2/ - постоянная Ричардсона. φВ – высота потенциального барьера.
Эмиссия Пула-Френкеля. В диэлектрических слоях, содержащих большое количество структурных дефектов и примесей, имеется высокая концентрация ловушек, способных захватывать носители.
Сильное электрическое поле может вызвать активацию свободных носителей заряда внутри самой диэлектрической пленки рис. 7.7. Эмиссия Пула-Френкеля это ускоренный электрическим полем процесс термовозбуждения электронов с ловушек в зону проводимости диэлектрика.

Рис. 7.7
Плотность тока эмиссии по Пулу-Френкелю равна
 ,
,
где В – коэффициент пропорциональности, φв – глубина ловушки.
Зависимости плотностей токов эмиссий по Шоттки и Пулу-Френкелю спрямляются в координатах lg j=f  .
.
Токи эмиссий Шоттки и Пула-Френкеля сильно зависят от температуры.
Литература
1. Пасынков В.В., Чиркин Л.К. Полупроводниковые приборы. СПб.: Издательство "Лань", 2001.
2. Степаненко И.П. Основы микроэлектроники. М.: Лаборатория базовых знаний, 2004.
3 Гуртов В.А. Твердотельная электроника. М.: Техносфера, 2007.
4. Ефимов И.Е., Козырь И.Я., Горбунов Ю.И. Микроэлектроника. М.: Высшая школа, 1986.
5. Епифанов Г.И., Мома Ю.А. Твердотельная электроника. М.: Высшая школа, 1986.
6. Опадчий Ю.Ф., Глудкин О.П., Гуров А.Л. Аналоговая и цифровая электроника. М.: «Горячая Линия – Телеком», 1999.
7. Основы радиоэлектроники. Под ред. Г.Д. Петрухина М.: Издательство МАИ, 1993.
8. Киселев В.Ф., Козлов С.Н., Зотеев А.В. Основы физики поверхности твердого тела. М.: Издательство МГУ, 1999 г.
9. Зи С. Физика полупроводниковых приборов. М.: Мир, 1984.
Приложение 1
Элементы квантовой механики и физической статистики
При физическом описании свойств твердых тел широко используются квантомеханические и статические представления. Чтобы избежать многочисленных ссылок на курс физики при изложении данного курса изложим основные положения квантовой механики и статической физики в краткой конспективной форме.
Волновые свойства частиц
К 20 веку было установлено, что атомные явления не могут быть описаны ни как движение частиц, ни как чисто волновые процессы. Так в явлениях дифракции, интерференции проявляется волновая природа света. В фотоэлектрических явлениях, эффекте Комптона (изменение частоты или длины волны фотонов при их рассеянии электронами) свет ведет себя как частица. В 1924 году французский физик де Бройль выдвинул гипотезу, что с каждым телом должна быть связана плоская волна.
 ,
,
где h – 6,6·10-34 Дж·с – постоянная Планка, p – импульс.
Гипотеза де Бройля получила убедительное экспериментальное подтверждение. На волновых свойствах микрочастиц основана электронная микроскопия, нейтронография. Микрочастицы – электроны, протоны нельзя представить в виде дробинки, уменьшенной до соответствующих размеров. Качественным отличительным признаком микрочастиц является органическое сочетание в них корпускулярных и волновых свойств.
Уравнение Шредингера.
Поскольку микрочастицы обладают волновыми свойствами, то и закон их движения должен описываться волновым уравнением. Впервые такое уравнение было записано Эрвином Шредингером (Австрия). Для микрочастицы, движущейся в силовом поле и обладающей потенциальной энергией u(x,y,z,t) оно имеет вид:
 ,
,
где i=  ,
,  -постоянная Планка, деленная на 2p.
-постоянная Планка, деленная на 2p.
Функция Ψ(x,y,z,t) является решением этого уравнения и называется волновой функцией. Она имеет следующий физический смысл: произведение Ψ на функцию Ψ* комплексно сопряженную с Ψ пропорционально вероятности того, что в момент времени t, микрочастица может быть обнаружена в выделенном объеме dV. Обозначим вероятность обнаружения микрочастицы в объеме dV через ω(x,y,z,t) dV. Тогда:
ω(x,y,z,t)dV= Ψ(x,y,z,t)Ψ*(x,y,z,t)dV.
Интеграл  , взятый по всему объему равен 1, т.к. он выражает достоверный факт, что микрочастица находится в этом объеме. Следовательно:
, взятый по всему объему равен 1, т.к. он выражает достоверный факт, что микрочастица находится в этом объеме. Следовательно:
 .
.
Это условие называется условием нормировки, а волновые функции, удовлетворяющие ему, называются нормированными.
Закон движения микрочастицы постоянно определяется заданием функции Ψ в каждый момент времени в каждой точке пространства.
Потенциальная энергия в общем случае является функцией координат и времени. Однако в большинстве практических задач u является функцией только координат. В этом случае волновую функцию Ψ(x,y,z,t) представляют в виде произведения функций Ψ(x,y,z) и φ(t):
Ψ(x,y,z,t) = Ψ(x,y,z)· φ(t). (1)
Рассмотрим движение микрочастицы вдоль оси Х. Тогда уравнение Шредингера можно записать:
 . (2)
. (2)
Подставим (2) в (1):
 .
.
Делим обе части на  :
:

Тогда левая часть уравнения зависит только от t, а правая только от х. Они могут быть равны друг другу только в том случае, если каждая равна одной и той же постоянной величине Е. Можно показать, что эта величина Е, есть полная энергия частицы Е. Можно записать приравнивая левую и правую части уравнения –Е:
 , откуда
, откуда
 . (3) (3)
. (3) (3)
 , откуда
, откуда
 . (4)
. (4)
В общем случае уравнение (3) будет содержать вторые производные по другим координатам:
 . (5)
. (5)
Через оператор Лапласа это уравнение можно записать так:
 .
.
Функция Ψ(x,y,z) зависящая только от координат называется амплитудной волновой функцией, а уравнение (5) амплитудным уравнением Шредингера.
Было доказано, что при движении микрочастицы в ограниченной области пространства амплитудное уравнение Шредингера имеет решение только при определенных значениях энергии Е – Е1, Е2…Еn, называемых собственными значениями энергии частицы. Волновые функции Ψ1, Ψ2, Ψ3,… Ψn, соответствующие этим энергиям, называются собственными волновыми функциями.
Решением уравнения (4) является:
 ,
,
где Еn – одно из собственных значений энергии. Функция φ(t) выражает зависимость волновой функции Ψ(x,y,z,t) от времени. Эта зависимость является гармонической с частотой υn=Еn / h или  .
.
Если потенциальная энергия является функцией только координат, то решение уравнения Шредингера может быть представлено в виде:
Ψ(x,y,z,t)= Ψ(x,y,z)exp(-iωt).
В этом случае вероятность обнаружения частицы в элементе объема равна:
ωdV=ΨΨ*dV
и не зависит от времени. Следовательно, распределение вероятности в пространстве является стационарным. Состояния микрочастиц, удовлетворяющие этому условию, называются стационарными состояниями. Амплитудное уравнение описывает стационарное состояние микрочастиц.
Соотношения неопределенности Гейзенберга
К микрочастицам, обладающим волновыми свойствами, применять понятия классической механики, например понятия координат частицы и ее импульса можно лишь в ограниченной степени.
Пусть частица движется вдоль оси Х и обладает импульсом рх. Такой частице соответствует волна λ=h/px, являющаяся по своей сущности протяженным объектом. Монохроматическая волна простирается по оси Х от -∞ до +∞. Следовательно, интервал локализации микрочастицы ∆х равен бесконечности. Т.е. микрочастица, имеющая определенный импульс рх, не имеет определенной координаты х. Можно показать, что микрочастица, имеющая определенную координату, не имеет определенного импульса. В отличие от классической частицы состояние микрочастицы не может быть охарактеризовано заданием одновременно определенных координат и составляющих импульса. Задать состояние микрочастицы можно лишь допуская неопределенность в значениях координат и значениях составляющих импульса. Количественно эта неопределенность описывается соотношениями записанными Гейзенбергом в 1927г.
∆x×∆px ≥ h; ∆y×∆py ≥ h; ∆z×∆pz ≥ h,
т.к. p=m×v, то
∆x×∆vx ≥  ; ∆y×∆vy ≥
; ∆y×∆vy ≥  ; ∆z×∆vz ≥
; ∆z×∆vz ≥  .
.
Из соотношений неопределенности следует, что чем точнее определяются координаты микрочастицы, тем неопределеннее становятся составляющие импульса. Поэтому бессмысленно говорить о траектории движения микрочастицы, т.е. о совокупности положений движущейся частицы в пространстве.
Соотношение неопределенности существует и между энергией и временем:
∆Е×∆t ≥ h ,
где ∆t – время, в течение которого частица обладает энергией Е  ∆Е.
∆Е.
Из соотношения неопределенности для энергии и времени следует, что неопределенность энергии возрастает при уменьшении времени пребывания микрочастицы в данном энергетическом состоянии.
Потенциальные барьеры для микрочастиц
Потенциальные барьеры и ямы для микрочастиц возникают, например, вследствие электрического взаимодействия электронов с ионами решетки в твердом теле, на границах раздела тел. Изменение потенциальной энергии частицы в зависимости от ее координат представляет собой потенциальный рельеф для этой частицы в заданном объеме. В кристаллах наблюдается периодический потенциальный рельеф, который в простейшем случае можно представить в виде совокупности одномерных прямоугольных барьеров, разделенных прямоугольными ямами.
Приложение 2
КОНСПЕКТ ЛЕКЦИЙ
по курсу
«ФИЗИЧЕСКИЕ ОСНОВЫ МИКРОЭЛЕКТРОНИКИ»
специальности 210201
«Проектирование и технология радиоэлектронных средств»
Утверждено на заседании
кафедры ЭИУ1-КФ
28.01.09 протокол № 6
Калуга, 2009 г.
Оглавление
Элементы зонной теории твердых тел
1.1. Электронный газ в периодическом потенциальном поле........... 3
1.2. Зоны Бриллюэна........................................................................... 7
1.3. Эффективная масса электрона..................................................... 8
1.4. Зонная схема кристаллических тел - проводники, диэлектрики, полупроводники........................................................................... 12
Дата: 2019-03-05, просмотров: 328.