В пластине n-типа выполняют селективное (выборочное) травление.
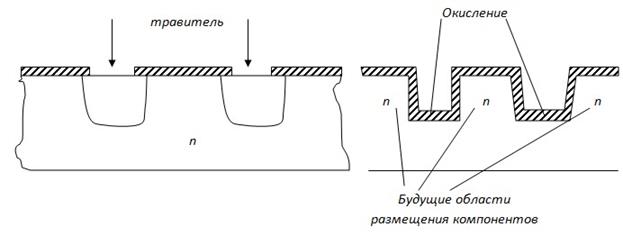 Затем наращивают на поверхности пластины с той стороны, где вытравлены пазы, слой поликристаллического кремния.
Затем наращивают на поверхности пластины с той стороны, где вытравлены пазы, слой поликристаллического кремния.
Далее сошлифовывают снизу весь монокристаллический слой кремния Si до уровня расположения изолирующего слоя карманов из SiO2.

После этого изготовление компонентов по планарной технологии (чередуя процессы фотолитографии и диффузии).
Изоляция диэлектрической плёнкой более совершенна (меньше связи с подложкой), но сложнее технология.
В одной пластине (диаметром 25-40 мм) изготавливается до нескольких сотен схем. Затем пластина режется на части и отдельные схемы-кристаллы монтируются в корпус.
Транзисторы ИПС.
Транзисторы гибридных схем являются дискретными и не имеют существенных особенностей, поэтому будем рассматривать только транзисторы ИПС с изоляцией обратносмещённым p-n переходом.
Главная особенность связана со способом изоляции. Получается четырёхслойная структура, которая приводит к появлению в эквивалентной схеме паразитного транзистора.
 Переход К-Б основного транзистора совмещён с переходом Э-Б паразитного транзистора.
Переход К-Б основного транзистора совмещён с переходом Э-Б паразитного транзистора.
Поэтому эквивалентная схема является совокупностью эквивалентных схем двух транзисторов, у которых общим является переход К-Б основного транзистора.
Рассмотрим возможные области работы паразитного транзистора. Этот транзистор находится в отсечке, когда у основного транзистора коллекторный переход заперт, то есть когда основной транзистор находится в отсечке или в активной области. При этом коллекторная цепь основного транзистора связана с подложкой через закрытый диод, то есть течёт отрицательный ток и имеется ёмкость этого перехода.
Если n-p-n транзистор находится в насыщении, то p-n-p транзистор – в активной области и через изолирующий переход течёт ток:
 ,
,
где B п – коэффициент усиления тока паразитного транзистора. Этот ток вреден, поэтому B п должен быть малым. Так оно и есть за счёт большой ширины коллекторной области, являющейся базовой в p-n-p транзисторе.
Ниже приведена таблица соответствий между режимами транзисторов двух типов (p-n-p и n-p-n).
| n-p-n | p-n-p |
| Отсечка | Отсечка |
| Активная область | Отсечка |
| Насыщение | Активная область |
| Инверсная активная область | Активная область |
Другая особенность связана с расположением коллекторного вывода (см. рисунок).
 Значительно увеличивается путь коллекторного тока в сравнительно высокоомной области, что означает рост
Значительно увеличивается путь коллекторного тока в сравнительно высокоомной области, что означает рост  . Как уменьшить
. Как уменьшить  ?
?
92-92-92
 Сравнение этих схем по основным параметрам диодов (U пр, t восст, U макс обр, C ак и C дп) дано в таблице. Сравнение по U макс обр и по C довольно простое. По U пр и t восст сравнение можно провести, используя нелинейную эквивалентную схему транзистора, в которой для упрощения пренебрегаем влиянием R уэ, R ук, r б и
Сравнение этих схем по основным параметрам диодов (U пр, t восст, U макс обр, C ак и C дп) дано в таблице. Сравнение по U макс обр и по C довольно простое. По U пр и t восст сравнение можно провести, используя нелинейную эквивалентную схему транзистора, в которой для упрощения пренебрегаем влиянием R уэ, R ук, r б и  (пренебрегаем также паразитным транзистором, оставляя от него только ёмкость C п).
(пренебрегаем также паразитным транзистором, оставляя от него только ёмкость C п).
U пр – прямое падение напряжения на диоде.
-

 . Так как
. Так как  , то
, то  .
. - По аналогии
 меньше, чем в предыдущем случае.
меньше, чем в предыдущем случае. - U бк > 0 и U бэ > 0;
 , чего и следовало ожидать, так как при равенстве напряжений на переходах концентрация носителей в базе постоянна. Следовательно,
, чего и следовало ожидать, так как при равенстве напряжений на переходах концентрация носителей в базе постоянна. Следовательно,
 , то есть
, то есть
 - больше, чем в 2, но меньше, чем в 1 при B и < 1.
- больше, чем в 2, но меньше, чем в 1 при B и < 1.
-

 .
. 
 больше, чем в первом случае.
больше, чем в первом случае. - По аналогии:
 меньше, чем в предыдущем случае, так как
меньше, чем в предыдущем случае, так как 
 .
.
t восст – время восстановления. Оно связано с рассасыванием заряда носителей тока, накопленных в базе (то есть заряда, накопленного в диффузионных ёмкостях переходов).
 .
.
-
 .
. - По аналогии
 . Здесь Q инж много больше, так как для дрейфовых транзисторов τи > τ и всегда B и < B.
. Здесь Q инж много больше, так как для дрейфовых транзисторов τи > τ и всегда B и < B. -
 , что больше, чем в предыдущем случае.
, что больше, чем в предыдущем случае. -

 , что меньше.
, что меньше. -

 .
.
Итак, схемы 3), 4) и 5) примерно равноценны – это медленные диоды. Схема 1) –быстрый диод.
При анализе U пр и t восст нужно отметить, что в схеме 1 – активная область, в схеме 2 – инверсная активная область, а в схемах 3, 4, 5 – насыщение.
t восст определяется временем рассасывания носителей, накопленных в базе, и это время при одинаковом I пр будет тем больше, чем больший заряд Q инж находится в диффузионных ёмкостях:
 .
.
Сравним, например, первую и четвёртую схемы.
В первой схеме  , поэтому
, поэтому  ;
;  .
.
В четвёртой схеме:  , откуда
, откуда  .
.
Прямой ток  .
.
Поэтому  оказывается больше, чем для первой схемы.
оказывается больше, чем для первой схемы.
Далее 
 .
.
То есть отношение зарядов, накопленных в базе в четвёртой и первой схемах:  , то есть разница больше, чем в B раз.
, то есть разница больше, чем в B раз.
Диоды с замкнутыми коллектором и базой называют быстрыми, а последние три разновидности – медленными.
Недостатком быстрого диода является малая величина допустимого обратного напряжения U обр макс, так как эмиттерный переход образован в сильнолегированном полупроводнике с малым пробивным напряжением.
Полученные выводы полностью справедливы для ИПС с диэлектрической изоляцией. При изоляции p-n переходом сказывается влияние этого перехода. Очевидно, что это влияние на U пр и t восст тем сильнее, чем больше B п паразитного n-p-n транзистора и сказывается во всех схемах, кроме первой, p-n-p транзистор находится в отсечке. При малых B п полученные выводы сохраняются.
Резисторы. В ИПС применяют так называемые диффузионные резисторы. По основным характеристикам (диапазон номинальных значений R, ТК, разброс параметров, паразитная ёмкость на подложку) они уступают тонкоплёночным, но благодаря их изготовлению в едином технологическом цикле с активными компонентами их выполнение проще.
Диффузионный резистор – это слой полупроводника, полученный в процессе эпитаксиального выращивания и разделительной диффузии (слой коллектора) или в процессе базовой диффузии (слой базы), или базовой и эмиттерной диффузии, когда используется слой базы под эмиттером или слой эмиттера. Наиболее часто резисторы изготавливаются на основе базовых слоёв.
 h =2,5-3,5 мкм.
h =2,5-3,5 мкм.  , где L – длина резистора, W – его ширина, h – толщина плёнки, ρ – удельное сопротивление.
, где L – длина резистора, W – его ширина, h – толщина плёнки, ρ – удельное сопротивление.
При проектировании резисторов можно выбирать L и W, а ρ и h определяются технологическим процессом базовой диффузии.  - это так называемое сопротивление слоя, имеющего форму квадрата. Оно не зависит от размера стороны квадрата и поэтому его размерность записывается как Ом/квадрат. ρ S – удельное поверхностное сопротивление. Слой базы имеет ρ S = 100-300 Ом/ ð. Выбираемая конфигурация резистора зависит от требуемого R . Минимальная ширина W зависит от разрешающей способности процесса фотолитографии - очевидно, что погрешности совмещения фотошаблонов с пластиной, а также погрешности изготовления самих шаблонов должны быть малыми по сравнению с W. Поэтому ширина ограничена снизу (W > 10 мкм) и в этом случае для большинства R требуются большие L. Кроме того, с увеличением R растут и паразитные ёмкости. При R > 50 кОм L становятся слишком большими, поэтому площади резисторов во много раз превышают площади транзисторов. Отсюда следуют два вывода:
- это так называемое сопротивление слоя, имеющего форму квадрата. Оно не зависит от размера стороны квадрата и поэтому его размерность записывается как Ом/квадрат. ρ S – удельное поверхностное сопротивление. Слой базы имеет ρ S = 100-300 Ом/ ð. Выбираемая конфигурация резистора зависит от требуемого R . Минимальная ширина W зависит от разрешающей способности процесса фотолитографии - очевидно, что погрешности совмещения фотошаблонов с пластиной, а также погрешности изготовления самих шаблонов должны быть малыми по сравнению с W. Поэтому ширина ограничена снизу (W > 10 мкм) и в этом случае для большинства R требуются большие L. Кроме того, с увеличением R растут и паразитные ёмкости. При R > 50 кОм L становятся слишком большими, поэтому площади резисторов во много раз превышают площади транзисторов. Отсюда следуют два вывода:
- Возможные величины R в ИПС ограничены сверху.
- Относительная стоимость резистора при больших номиналах оказывается выше стоимости транзистора.
Эквивалентная схема диффузионного резистора, построенного на базовом слое приведена ниже.
 Если пренебречь обратными токами диодов, то остаются только ёмкости на подложку.
Если пренебречь обратными токами диодов, то остаются только ёмкости на подложку.
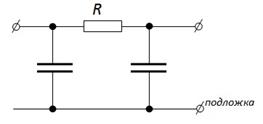
Некоторые параметры диффузионных резисторов.
| Диапазон сопротивлений | Тип диффузии | Сопротивление слоя | ТКС 10-6/°С | Допуск |
| 200 – 30000 | Базовая | 200 | 2500 | ±20% |
| 100 – 20000 | Базовая | 100 | 1500 | |
| 2,5 - 1000 | Эмиттерная | 2,5 | 100 |
Плёночные резисторы.
| Материал | Сопротивление слоя | ТКС 10-6/°С | Допуск, % |
| Нихром | 10 – 400 | ±100 | ±5 |
| Двуокись олова | 25 – 1000 | ±500 | ±15 |
| Нитрид тантала | 50 – 500 | ±100 | ±10 |
| Металлокерамика | 100 - 20000 | ±300 | ±20 |
Частотный диапазон.
10 – 20 МГц – с изоляцией p-n переходом.
50 – 60 МГц – с диэлектрической изоляцией.
Несколько сотен МГц – тонкоплёночные резисторы.
Мощность рассеяния.
Полупроводниковые – 4,6 Вт/мм2. Плёночные – 3,1 Вт/мм2.
Конденсаторы.
В ИПС в качестве конденсаторов используются обратносмещённые p-n переходы (диффузионные конденсаторы) или МДП-структуры. В совмещённых и гибридных схемах – плёночные конденсаторы.
Конденсаторы ИПС имеют удельные ёмкости в несколько сотен пФ/мм2, следовательно номиналы С также имеют существенные ограничения сверху.
В качестве конденсатора можно использовать любой из трёх p-n переходов интегральной транзисторной структуры.
Если N (концентрация примесей в областях, прилегающих к переходу) растёт, то растёт и удельная ёмкость C уд, что хорошо, но вместе с этим падает U обр макс, что является недостатком. Следовательно, удельная ёмкость конденсатора, образованного на эмиттерном переходе, будет наибольшей, но у такой ёмкости будет наименьшее пробивное напряжение.

 Паразитное объёмное сопротивление здесь сравнительно мало, так как вывод выполняется на большом участке базы. Следует отметить, что все диффузионные конденсаторы полярны, и их ёмкость зависит от приложенного к ним напряжения.
Паразитное объёмное сопротивление здесь сравнительно мало, так как вывод выполняется на большом участке базы. Следует отметить, что все диффузионные конденсаторы полярны, и их ёмкость зависит от приложенного к ним напряжения.
Для нормальной работы схемы нужно, чтобы Д1 и Д были заперты. Для этого p-подложка подключается к самому низкому потенциалу в схеме, а конденсатор – с учётом его полярности.
Ёмкость С1 диода Д1 является паразитной. Отношение С/С1 составляет несколько единиц и меняется при изменении потенциалов в точках А и В.
МДП-конденсаторы имеют ряд преимуществ.

1) Они работают при любой полярности напряжений, то есть они неполярны.
2) Меньше паразитное последовательное сопротивление, так как эмиттерный слой сильно легирован.
3) Суд определяется толщиной слоя диэлектрика, которая обычно берётся равной около 0,1 мм.
Полупроводниковые конденсаторы.
| Суд | Переход К-П | Переход К-Б | Переход Э-Б |
| пф/мм2 | 150 | 310 | 1500 |
Плёночные конденсаторы.
| SiO2 | Al2O3 | Ta2O5 | |
| C уд , пФ/мм2 | 400 - 640 | 480 – 800 | 4000 |
| Смакс, пФ | 500 | 1000 | 5000 |
| Допуск, % | ±20 | ±20 | ±20 |
ТК-ёмкости: 0,03 %/°С – МДП. 0,1 %/°С – p-n.
Лекция 16.
Дата: 2018-12-28, просмотров: 426.