Глава 1. Вольт-амперные характеристики транзисторов.
Транзистор как усилительный прибор.
На рисунках ниже представлено схематическое устройство транзистора.
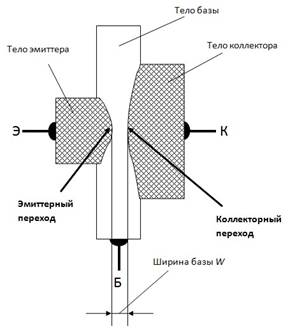
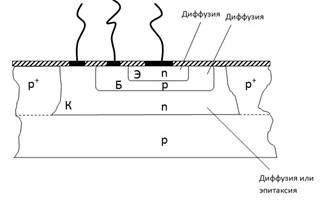
Транзистор – усилительный прибор, один из электродов которого всегда подключается так, что является общим по отношению ко входу и выходу, другой электрод – управляющий, а третий включён в цепь нагрузки. Малые значения напряжения u или тока i управляющего электрода вызывают значительно большие изменения напряжения u и I выходного электрода.
Различают транзисторы:
· p-n-p и n-p-n типов;
· германиевые (Ge) и кремниевые (Si);
· точечные и плоскостные;
· биполярные и униполярные (полевые);
· дрейфовые и бездрейфовые.
Для транзисторов p-n-p и n-p-n типов введены отличающиеся условные графические изображения (УГО), которые представлены на рисунке.
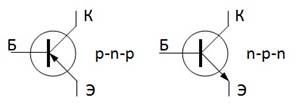
Лекция 8.
(???)
Схема токов через выводы транзистора.
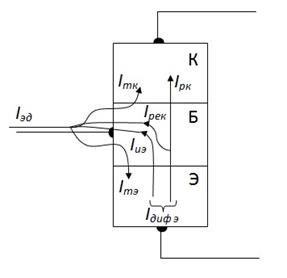 При рассмотрении модели транзистора обратными токами мы пренебрегаем. Эти токи (ток I иэ и ток рекомбинации I рек) необходимо уменьшить. Ток I иэ снижают, легируя базу значительно слабее эмиттера.
При рассмотрении модели транзистора обратными токами мы пренебрегаем. Эти токи (ток I иэ и ток рекомбинации I рек) необходимо уменьшить. Ток I иэ снижают, легируя базу значительно слабее эмиттера.
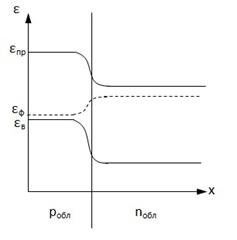
В соответствии с функцией распределения Ферми, концентрация дырок в эмиттере будет значительно выше, чем электронов в базе,т.е. pp >> nn. Это приводит к тому, что I рэ >> I иэ и
 - коэффициент инжекции (эффективность эмиттера).
- коэффициент инжекции (эффективность эмиттера).
I рек снижают при помощи уменьшения ширины базы: W << L.
I рек << I рк и  - коэффициент переноса.
- коэффициент переноса.
Определим α как  . Величина
. Величина  называется коэффициентом усиления по току транзистора, включённого по схеме ОБ. Практическое значение этого коэффициента лежит в пределах 0,9 – 0,995.
называется коэффициентом усиления по току транзистора, включённого по схеме ОБ. Практическое значение этого коэффициента лежит в пределах 0,9 – 0,995.
Коэффициент усиления по току в схеме ОЭ определяется следующим образом:
 , так как I э = I к + I б.
, так как I э = I к + I б.  , причём коэффициент обычно лежит в пределах от 9 до 300.
, причём коэффициент обычно лежит в пределах от 9 до 300.
Теперь учтём обратный ток: I ко = Iтк+ I ук , I эо = Iтэ+ I уэ . Обычно I ко >> I эо и I эо пренебрегают, тогда
 или
или 
 . Обратный ток I ко вреден (его величина составляет от пикоампер до десятков микроампер).
. Обратный ток I ко вреден (его величина составляет от пикоампер до десятков микроампер).
Контрольные вопросы.
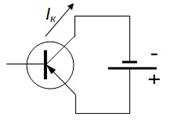
- База оборвана. Чем определяется I к ?
- Есть ли усиление по току в схемах ОБ и ОК?
- Нарисуйте энергетические диаграммы транзистора в схеме при обоих закрытых переходах.
Лекция 9.
Области работы.
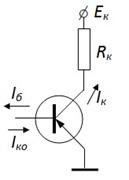 Отсечка: I б =- I ко.
Отсечка: I б =- I ко.
Энергетические диаграммы.

В этой области работы усилительных свойств у транзистора нет.
Насыщение: U кэ = U вых = U кб - U эб  0.
0.
 Изменения I б не приводят к изменениям U к, а значит изменениям I к.
Изменения I б не приводят к изменениям U к, а значит изменениям I к.

Инверсная активная область (ИАО):
U кб >0, Uэб<0, транзистор работает как бы в обращённом режиме: функции эмиттера выполняет коллектор, а коллектора – эмиттер.
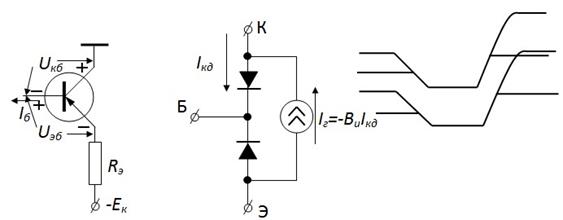
В этом режиме соответственно и изменяется коэффициент усиления по току в схемах ОБ и ОЭ αи и βи (лежат в пределах 0,001 – 0,95 и 0,001 – 20 соответственно).
Модуляция базы.
Ранее установлено, что при изменении напряжения, приложенного к p-n переходу, изменяется ширина обеднённой области. Распространение её происходит в основном в сторону области полупроводникового материала с меньшей концентрацией примесей. Так как база менее легирована, чем коллектор, то при изменении U кб (оно обычно велико) происходит изменение ширины базовой области.
Следует рассматривать этот процесс при двух различных режимах работы эмиттерного перехода.
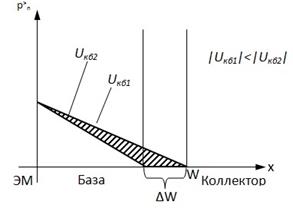 а) Эмиттерный переход питается от источника напряжения.
а) Эмиттерный переход питается от источника напряжения.
С увеличением | U кб | уменьшается ширина базы, растёт градиент концентрации примесей  , а, следовательно, плотность дырочного тока через эмиттерный переход равна:
, а, следовательно, плотность дырочного тока через эмиттерный переход равна:  , а, следовательно, и сам ток
, а, следовательно, и сам ток  .
.
Кроме того, так как уменьшается ширина базы, уменьшается количество рекомбинировавших дырок на пути их движения к коллектору, следовательно, растёт коэффициент переноса β, а вместе с ним α и B . Отсюда следует, что связь между токами эмиттера или базы и напряжением U эб можно выразить семейством вольт-амперных характеристик.

так как  .
.
б) Эмиттерный переход питается от источника тока.
1) Генератор тока стоит в цепи эмиттера. 2) Генератор тока стоит в цепи базы.
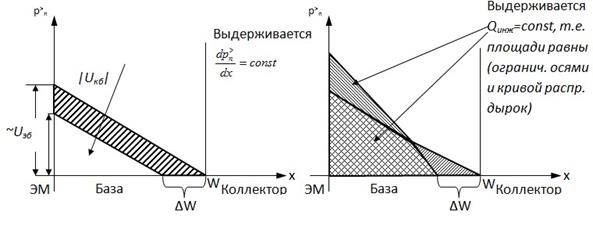
Дрейфовые транзисторы.
Транзисторы, изготовленные по диффузионной технологии, имеют неоднородное (неравномерное) распределение примесей в базе. Это приводит к возникновению в базе электрического поля, направленного в p-n-p транзисторах от эмиттера к коллектору и, следовательно, ускоряющего движение инжектированных дырок. Также транзисторы, у которых неосновные носители тока в базе перемещаются преимущественно под действием сил дрейфа в электрическом поле, называются дрейфовыми.
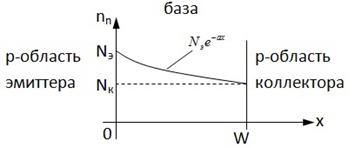




 , откуда следует, что напряжённость поля в базе будет равна
, откуда следует, что напряжённость поля в базе будет равна

Таким образом, поле в базе постоянно, то есть не зависит от координаты x при экспоненциальном распределении примесей.
 , где
, где  называется коэффициентом поля.
называется коэффициентом поля.
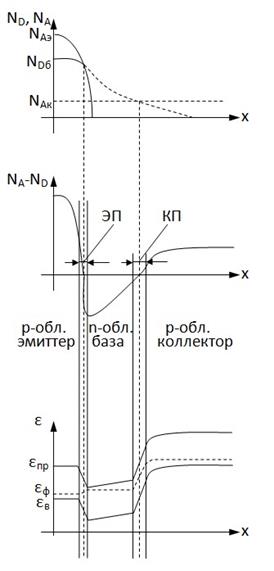 Концентрация доноров в базе возле эмиттера больше, чем возле коллектора, а это приводит к наклону энергетических уровней. Ясно, что такой наклон энергетических уровней способствует движению дырок к коллектору.
Концентрация доноров в базе возле эмиттера больше, чем возле коллектора, а это приводит к наклону энергетических уровней. Ясно, что такой наклон энергетических уровней способствует движению дырок к коллектору.
Результат: время пролёта дырок через базу (ранее обозначенное как τα) уменьшается, а fα растёт. Более быстрый перенос дырок через базу способствует увеличению коэффициента переноса β, a , следовательно и α с B. Однако увеличение fα происходит быстрее, чем B, поэтому у дрейфовых транзисторов более высокими оказываются и значения f в.
 .
.
Таким образом, отличия дрейфовых транзисторов от бездрейфовых заключаются в лучших числовых значениях ряда параметров, а системы параметров и эквивалентные схемы остаются прежними.
Для того, чтобы сделать транзистор более высокочастотным, нужно увеличивать коэффициент поля, но этому препятствует уменьшение эффективности эмиттера γ (при увеличении N э) и невозможность уменьшения N к, так как при этом снижается рабочий диапазон температур. Можно уменьшать толщину базы, но только лишь до тех пор, пока это допускают требуемые пробивные напряжения коллекторного перехода (чтобы не было перекрытия базы).
Лекция 12.
Обозначения транзисторов.
При выборе типов транзисторов для разрабатываемой схемы инженеру в первую очередь нужно знать параметры P макс и fα (или f в, или f макс).
Обозначения транзисторов связаны с их классификацией по частоте и мощности. Кроме того, в обозначении указывается тип полупроводника.
Первый символ: Г (или 1) – германий, К (или 2) – кремний, А (или 3) – арсенид галлия.
Второй символ: Т – транзистор, Д – диод, Ф – фотоприбор, И – туннельный диод, С – стабилитрон, Н – неуправляемый многослойный переключательный прибор, У – управляемый многослойный переключательный прибор (тиристор).
Далее идёт число (трёхразрядное), которое говорит о P макс и fα. Ниже приведена таблица этих чисел в зависимости от P макс и fα.
| Малая мощность P к < 0,3 Вт | Средняя мощность 0,3 Вт < P к < 1,5 Вт | Большая мощность P к > 1,5 Вт | |
| Низкая частота fα < 3 МГц | 101-199 | 401-499 | 701-799 |
| Средняя частота 3МГц < fα < 3 0МГц | 201-299 | 501-599 | 801-899 |
| Высокая частота fα > 30 МГц | 301-399 | 601-699 | 901-999 |
Последний символ: буква (её может и не быть) – номер модификации.
Например, 2Т319 или КТ319 – кремниевый транзистор (маломощный, высокочастотный).
Такая система обозначений была введена в 1964 г. Приборы более ранних разработок обозначаются иначе. Транзисторы имеют в обозначении букву П (что означает плоскостной тип) и число. Например, П13А, МП42, П416Б (число здесь не связано с приведённой выше таблицей).
Классификация ИС.
Интегральные схемы делятся на два крупных класса:
1) ИПС – интегральные полупроводниковые схемы;
2) Гибридные схемы.
Место этих двух групп ИС можно показать при помощи рисунка.
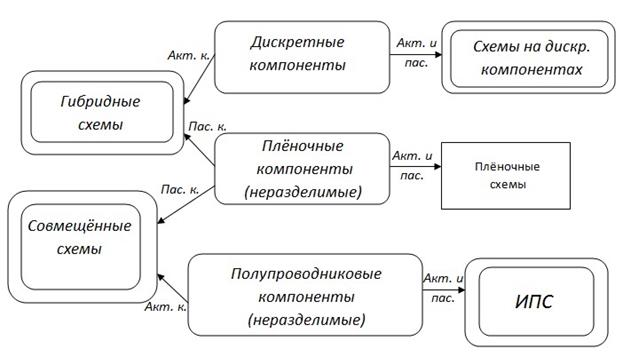 Лекция 14.
Лекция 14.
ИПС изготавливаются внутри полупроводниковой подложки, имеющей кристаллическую структуру. Как правило, для подложки выбирается кремний (Si), так как он очень удобен для создания защитных плёнок (оксид кремния – SiO2) на поверхности пластины простым окислением. ИС, у которых подложка и компоненты выполнены из одного материала, называются монолитными (твёрдыми).
Гибридные схемы обладают подложкой из керамики или стекла. На эту подложку наносятся пассивные компоненты в виде тонких плёнок металла (толщина до 100 мкм) – тонкоплёночные гибридные схемы – или в виде так называемых толстых плёнок из металлорезистивной пасты (толщиной свыше 100 мкм) – толстоплёночные схемы. Составные компоненты изготавливаются отдельно.
Это специальные бескорпусные дискретные приборы, которые монтируются на подложке и соединяются с другими компонентами тонкими проволочками.
Кроме двух названных основных групп ИС, существуют следующие:
Совмещённые. Подложка полупроводниковая. Активные компоненты изготавливаются в подложке методом диффузии и эпитаксиального выращивания, то есть так же, как и у монолитных схем. Пассивные компоненты наносятся в виде тонких плёнок на слой оксида кремния SiO2.
Плёночные. В отличие от гибридных схем все компоненты изготавливаются методами плёночной технологии.
Сравнение ИС. Пассивные компоненты ИПС уступают по своим параметрам плёночным компонентам: 1) у них существенно ограничены сверху допустимые номиналы сопротивлений и ёмкостей; 2) большой разброс параметров; 3) хуже стабильность. В то же время компоненты ИПС позволяют иметь более высокую плотность установки. Также могут иметь наибольшую надёжность и наименьшую стоимость. По этим причинам ИПС являются более перспективными.
Технология изготовления наиболее проста у гибридных схем, а затем у ИПС. В совмещённых схемах стремятся совместить преимущества ИПС и плёночных пассивных компонентов, но сложнее технология. Наконец, технология плёночных активных компонентов практически не освоена.
Транзисторы ИПС.
Транзисторы гибридных схем являются дискретными и не имеют существенных особенностей, поэтому будем рассматривать только транзисторы ИПС с изоляцией обратносмещённым p-n переходом.
Главная особенность связана со способом изоляции. Получается четырёхслойная структура, которая приводит к появлению в эквивалентной схеме паразитного транзистора.
 Переход К-Б основного транзистора совмещён с переходом Э-Б паразитного транзистора.
Переход К-Б основного транзистора совмещён с переходом Э-Б паразитного транзистора.
Поэтому эквивалентная схема является совокупностью эквивалентных схем двух транзисторов, у которых общим является переход К-Б основного транзистора.
Рассмотрим возможные области работы паразитного транзистора. Этот транзистор находится в отсечке, когда у основного транзистора коллекторный переход заперт, то есть когда основной транзистор находится в отсечке или в активной области. При этом коллекторная цепь основного транзистора связана с подложкой через закрытый диод, то есть течёт отрицательный ток и имеется ёмкость этого перехода.
Если n-p-n транзистор находится в насыщении, то p-n-p транзистор – в активной области и через изолирующий переход течёт ток:
 ,
,
где B п – коэффициент усиления тока паразитного транзистора. Этот ток вреден, поэтому B п должен быть малым. Так оно и есть за счёт большой ширины коллекторной области, являющейся базовой в p-n-p транзисторе.
Ниже приведена таблица соответствий между режимами транзисторов двух типов (p-n-p и n-p-n).
| n-p-n | p-n-p |
| Отсечка | Отсечка |
| Активная область | Отсечка |
| Насыщение | Активная область |
| Инверсная активная область | Активная область |
Другая особенность связана с расположением коллекторного вывода (см. рисунок).
 Значительно увеличивается путь коллекторного тока в сравнительно высокоомной области, что означает рост
Значительно увеличивается путь коллекторного тока в сравнительно высокоомной области, что означает рост  . Как уменьшить
. Как уменьшить  ?
?
92-92-92
 Сравнение этих схем по основным параметрам диодов (U пр, t восст, U макс обр, C ак и C дп) дано в таблице. Сравнение по U макс обр и по C довольно простое. По U пр и t восст сравнение можно провести, используя нелинейную эквивалентную схему транзистора, в которой для упрощения пренебрегаем влиянием R уэ, R ук, r б и
Сравнение этих схем по основным параметрам диодов (U пр, t восст, U макс обр, C ак и C дп) дано в таблице. Сравнение по U макс обр и по C довольно простое. По U пр и t восст сравнение можно провести, используя нелинейную эквивалентную схему транзистора, в которой для упрощения пренебрегаем влиянием R уэ, R ук, r б и  (пренебрегаем также паразитным транзистором, оставляя от него только ёмкость C п).
(пренебрегаем также паразитным транзистором, оставляя от него только ёмкость C п).
U пр – прямое падение напряжения на диоде.
-

 . Так как
. Так как  , то
, то  .
. - По аналогии
 меньше, чем в предыдущем случае.
меньше, чем в предыдущем случае. - U бк > 0 и U бэ > 0;
 , чего и следовало ожидать, так как при равенстве напряжений на переходах концентрация носителей в базе постоянна. Следовательно,
, чего и следовало ожидать, так как при равенстве напряжений на переходах концентрация носителей в базе постоянна. Следовательно,
 , то есть
, то есть
 - больше, чем в 2, но меньше, чем в 1 при B и < 1.
- больше, чем в 2, но меньше, чем в 1 при B и < 1.
-

 .
. 
 больше, чем в первом случае.
больше, чем в первом случае. - По аналогии:
 меньше, чем в предыдущем случае, так как
меньше, чем в предыдущем случае, так как 
 .
.
t восст – время восстановления. Оно связано с рассасыванием заряда носителей тока, накопленных в базе (то есть заряда, накопленного в диффузионных ёмкостях переходов).
 .
.
-
 .
. - По аналогии
 . Здесь Q инж много больше, так как для дрейфовых транзисторов τи > τ и всегда B и < B.
. Здесь Q инж много больше, так как для дрейфовых транзисторов τи > τ и всегда B и < B. -
 , что больше, чем в предыдущем случае.
, что больше, чем в предыдущем случае. -

 , что меньше.
, что меньше. -

 .
.
Итак, схемы 3), 4) и 5) примерно равноценны – это медленные диоды. Схема 1) –быстрый диод.
При анализе U пр и t восст нужно отметить, что в схеме 1 – активная область, в схеме 2 – инверсная активная область, а в схемах 3, 4, 5 – насыщение.
t восст определяется временем рассасывания носителей, накопленных в базе, и это время при одинаковом I пр будет тем больше, чем больший заряд Q инж находится в диффузионных ёмкостях:
 .
.
Сравним, например, первую и четвёртую схемы.
В первой схеме  , поэтому
, поэтому  ;
;  .
.
В четвёртой схеме:  , откуда
, откуда  .
.
Прямой ток  .
.
Поэтому  оказывается больше, чем для первой схемы.
оказывается больше, чем для первой схемы.
Далее 
 .
.
То есть отношение зарядов, накопленных в базе в четвёртой и первой схемах:  , то есть разница больше, чем в B раз.
, то есть разница больше, чем в B раз.
Диоды с замкнутыми коллектором и базой называют быстрыми, а последние три разновидности – медленными.
Недостатком быстрого диода является малая величина допустимого обратного напряжения U обр макс, так как эмиттерный переход образован в сильнолегированном полупроводнике с малым пробивным напряжением.
Полученные выводы полностью справедливы для ИПС с диэлектрической изоляцией. При изоляции p-n переходом сказывается влияние этого перехода. Очевидно, что это влияние на U пр и t восст тем сильнее, чем больше B п паразитного n-p-n транзистора и сказывается во всех схемах, кроме первой, p-n-p транзистор находится в отсечке. При малых B п полученные выводы сохраняются.
Резисторы. В ИПС применяют так называемые диффузионные резисторы. По основным характеристикам (диапазон номинальных значений R, ТК, разброс параметров, паразитная ёмкость на подложку) они уступают тонкоплёночным, но благодаря их изготовлению в едином технологическом цикле с активными компонентами их выполнение проще.
Диффузионный резистор – это слой полупроводника, полученный в процессе эпитаксиального выращивания и разделительной диффузии (слой коллектора) или в процессе базовой диффузии (слой базы), или базовой и эмиттерной диффузии, когда используется слой базы под эмиттером или слой эмиттера. Наиболее часто резисторы изготавливаются на основе базовых слоёв.
 h =2,5-3,5 мкм.
h =2,5-3,5 мкм.  , где L – длина резистора, W – его ширина, h – толщина плёнки, ρ – удельное сопротивление.
, где L – длина резистора, W – его ширина, h – толщина плёнки, ρ – удельное сопротивление.
При проектировании резисторов можно выбирать L и W, а ρ и h определяются технологическим процессом базовой диффузии.  - это так называемое сопротивление слоя, имеющего форму квадрата. Оно не зависит от размера стороны квадрата и поэтому его размерность записывается как Ом/квадрат. ρ S – удельное поверхностное сопротивление. Слой базы имеет ρ S = 100-300 Ом/ ð. Выбираемая конфигурация резистора зависит от требуемого R . Минимальная ширина W зависит от разрешающей способности процесса фотолитографии - очевидно, что погрешности совмещения фотошаблонов с пластиной, а также погрешности изготовления самих шаблонов должны быть малыми по сравнению с W. Поэтому ширина ограничена снизу (W > 10 мкм) и в этом случае для большинства R требуются большие L. Кроме того, с увеличением R растут и паразитные ёмкости. При R > 50 кОм L становятся слишком большими, поэтому площади резисторов во много раз превышают площади транзисторов. Отсюда следуют два вывода:
- это так называемое сопротивление слоя, имеющего форму квадрата. Оно не зависит от размера стороны квадрата и поэтому его размерность записывается как Ом/квадрат. ρ S – удельное поверхностное сопротивление. Слой базы имеет ρ S = 100-300 Ом/ ð. Выбираемая конфигурация резистора зависит от требуемого R . Минимальная ширина W зависит от разрешающей способности процесса фотолитографии - очевидно, что погрешности совмещения фотошаблонов с пластиной, а также погрешности изготовления самих шаблонов должны быть малыми по сравнению с W. Поэтому ширина ограничена снизу (W > 10 мкм) и в этом случае для большинства R требуются большие L. Кроме того, с увеличением R растут и паразитные ёмкости. При R > 50 кОм L становятся слишком большими, поэтому площади резисторов во много раз превышают площади транзисторов. Отсюда следуют два вывода:
- Возможные величины R в ИПС ограничены сверху.
- Относительная стоимость резистора при больших номиналах оказывается выше стоимости транзистора.
Эквивалентная схема диффузионного резистора, построенного на базовом слое приведена ниже.
 Если пренебречь обратными токами диодов, то остаются только ёмкости на подложку.
Если пренебречь обратными токами диодов, то остаются только ёмкости на подложку.
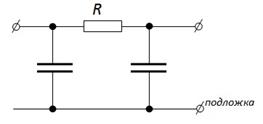
Некоторые параметры диффузионных резисторов.
| Диапазон сопротивлений | Тип диффузии | Сопротивление слоя | ТКС 10-6/°С | Допуск |
| 200 – 30000 | Базовая | 200 | 2500 | ±20% |
| 100 – 20000 | Базовая | 100 | 1500 | |
| 2,5 - 1000 | Эмиттерная | 2,5 | 100 |
Плёночные резисторы.
| Материал | Сопротивление слоя | ТКС 10-6/°С | Допуск, % |
| Нихром | 10 – 400 | ±100 | ±5 |
| Двуокись олова | 25 – 1000 | ±500 | ±15 |
| Нитрид тантала | 50 – 500 | ±100 | ±10 |
| Металлокерамика | 100 - 20000 | ±300 | ±20 |
Частотный диапазон.
10 – 20 МГц – с изоляцией p-n переходом.
50 – 60 МГц – с диэлектрической изоляцией.
Несколько сотен МГц – тонкоплёночные резисторы.
Мощность рассеяния.
Полупроводниковые – 4,6 Вт/мм2. Плёночные – 3,1 Вт/мм2.
Конденсаторы.
В ИПС в качестве конденсаторов используются обратносмещённые p-n переходы (диффузионные конденсаторы) или МДП-структуры. В совмещённых и гибридных схемах – плёночные конденсаторы.
Конденсаторы ИПС имеют удельные ёмкости в несколько сотен пФ/мм2, следовательно номиналы С также имеют существенные ограничения сверху.
В качестве конденсатора можно использовать любой из трёх p-n переходов интегральной транзисторной структуры.
Если N (концентрация примесей в областях, прилегающих к переходу) растёт, то растёт и удельная ёмкость C уд, что хорошо, но вместе с этим падает U обр макс, что является недостатком. Следовательно, удельная ёмкость конденсатора, образованного на эмиттерном переходе, будет наибольшей, но у такой ёмкости будет наименьшее пробивное напряжение.

 Паразитное объёмное сопротивление здесь сравнительно мало, так как вывод выполняется на большом участке базы. Следует отметить, что все диффузионные конденсаторы полярны, и их ёмкость зависит от приложенного к ним напряжения.
Паразитное объёмное сопротивление здесь сравнительно мало, так как вывод выполняется на большом участке базы. Следует отметить, что все диффузионные конденсаторы полярны, и их ёмкость зависит от приложенного к ним напряжения.
Для нормальной работы схемы нужно, чтобы Д1 и Д были заперты. Для этого p-подложка подключается к самому низкому потенциалу в схеме, а конденсатор – с учётом его полярности.
Ёмкость С1 диода Д1 является паразитной. Отношение С/С1 составляет несколько единиц и меняется при изменении потенциалов в точках А и В.
МДП-конденсаторы имеют ряд преимуществ.

1) Они работают при любой полярности напряжений, то есть они неполярны.
2) Меньше паразитное последовательное сопротивление, так как эмиттерный слой сильно легирован.
3) Суд определяется толщиной слоя диэлектрика, которая обычно берётся равной около 0,1 мм.
Полупроводниковые конденсаторы.
| Суд | Переход К-П | Переход К-Б | Переход Э-Б |
| пф/мм2 | 150 | 310 | 1500 |
Плёночные конденсаторы.
| SiO2 | Al2O3 | Ta2O5 | |
| C уд , пФ/мм2 | 400 - 640 | 480 – 800 | 4000 |
| Смакс, пФ | 500 | 1000 | 5000 |
| Допуск, % | ±20 | ±20 | ±20 |
ТК-ёмкости: 0,03 %/°С – МДП. 0,1 %/°С – p-n.
Лекция 16.
Четырёхслойные структуры.
Четырёхслойные структуры типа p-n-p-n могут иметь два, три или четыре вывода.
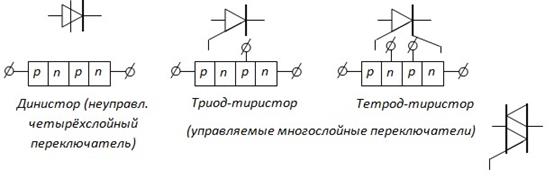
Тиристоры в настоящее время широко используются в силовой и преобразовательной технике (мощные источники питания), где они успешно заменяют ионные приборы. Тиристоры могут работать при напряжениях в сотни вольт и токах в десятки ампер. В импульсных схемах тиристоры пока применяются реже, чему мешает их недостаточно высокое быстродействие. Однако тиристоры позволяют строить многие схемы более просто, чем на транзисторах, и высказывается мнение, что их частотные свойства будут улучшаться. Сейчас в ключевых схемах времена включения тиристоров порядка 0,1 – 0,3 мкс, времена выключения – 1 – 35 мкс.
Диод-тиристор.
 Тиристор можно представить как совокупность двух транзисторов
Тиристор можно представить как совокупность двух транзисторов
p-n-p (области О1 - О2 - О3)
n-p-n (области О4 – О3 – О2).
Вольт-амперная характеристика тиристора имеет S-образную форму с участком отрицательного сопротивления.
 Участок напряжения от 0 до U 1 при I < I 1, П1 и П3 открыты, П2 закрыт. Обе составляющие транзистора находятся в активной области и их эмиттерные токи (переходы ???
Участок напряжения от 0 до U 1 при I < I 1, П1 и П3 открыты, П2 закрыт. Обе составляющие транзистора находятся в активной области и их эмиттерные токи (переходы ???
нет переход П2 течёт тоже ток I:
 ,
,
где полагаем, что коэффициент лавинного размножения M = M 1 = M 2. Иначе:
 , (1)
, (1)
что имеет смысл только при  . Если же
. Если же  , то предположение о закрытии коллекторного перехода неверно.
, то предположение о закрытии коллекторного перехода неверно.
Коэффициенты α1 и α2 меньше, чем у обычных транзисторов. При малом токе I они меньше 0,5, то есть α1+α2 < 1, а при большом I - α1+α2 > 1. Малые величины α связаны с большими толщинами базовых областей О2 и О3. Кроме того, α зависят от напряжения на переходе. С увеличением напряжения на П2 увеличивается и М (становится больше 1). Эти зависимости связаны с модуляцией баз и, главным образом, с лавинным умножением в переходе П2.
Увеличение напряжения приводит к росту M, и следовательно к увеличению I, что в свою очередь ведёт к увеличению α1+α2, а это ведёт также к росту I. Отсюда значительно более быстрое увеличение тока в цепи при нарастании внешнего напряжения, и появление участка с отрицательным сопротивлением. Наконец, наступает такой момент, когда выражение (1) теряет физический смысл (при  ). Этого быть не может, так как ток всегда протекает от + к -. В этот момент открывается переход П2. Теперь все переходы открыты. U составляет не более 1,0 – 1,5 В, тиристор оказывается во включённом состоянии, а составляющие его транзисторы – в насыщении.
). Этого быть не может, так как ток всегда протекает от + к -. В этот момент открывается переход П2. Теперь все переходы открыты. U составляет не более 1,0 – 1,5 В, тиристор оказывается во включённом состоянии, а составляющие его транзисторы – в насыщении.
 Физика этого явления объясняется ниже. Ток α1 IM приводит к накоплению дырок в О3, а ток α2 IM – к накоплению электронов в О2.
Физика этого явления объясняется ниже. Ток α1 IM приводит к накоплению дырок в О3, а ток α2 IM – к накоплению электронов в О2.
Если α1 M и α2 M малы, то приходящие в соответствующие области дырки и электроны успевают рекомбинировать. При больших α1 M и α2 M создаётся их избыток, что ведёт к повышению энергетического уровня в О2 (отрицательный заряд) и к его понижению в О3 (положительный заряд). Из энергетических диаграмм видно, что это эквивалентно большему открыванию переходов П1 и П3 и резкому увеличению тока I.
Если бы не было ограничивающего сопротивления R н, то этот рост тока вывел бы тиристор из строя. Наличие сопротивления приводит к уменьшению напряжения. Таким образом, увеличение тока I вызывает уменьшение U, что означает отрицательное дифференциальное сопротивление.
Таким образом, включение диода-тиристора произойдёт при E > U 1 . Выключение, если снизить ток до величины I 2. При I 2 и U 2 α1М + α2М ≤ 1 и происходит выключение  .
.
Триод-тиристор. С помощью управляющего электрода легко осуществлять включение и выключение тиристора. При I у > 0 в О3 вводятся дополнительные дырки и быстрее (раньше) накапливается необходимый для переключения заряд. Ускоряется включение. При I у < 0 – наоборот.
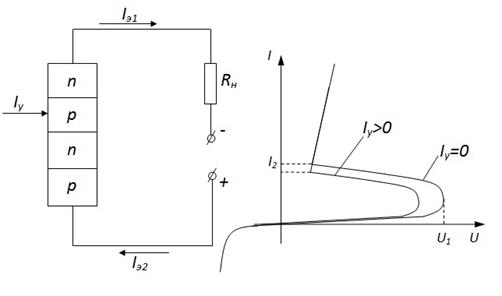
Включение тиристора можно осуществлять увеличением I у. Выключение основано на том, что I 2 зависит от I у, хотя зависимость недостаточно сильная.
 Тетрод-тиристор. Добавляется управление по базе n, действующее аналогично управлению по базе p. Зависимости I от U теперь можно представить совокупностью семейств характеристик. Например:
Тетрод-тиристор. Добавляется управление по базе n, действующее аналогично управлению по базе p. Зависимости I от U теперь можно представить совокупностью семейств характеристик. Например:  при I у2 = const.
при I у2 = const.
Параметры:
Номинального режима: I вкл, I уд, U откр (I откр), I обр (U обр), r дин, C общ, t вкл, t выкл.
Предельно допустимые: P ср макс, I откр макс, I откр н макс, U обр макс.
[11]Доделать
[12]А где 10?
Глава 1. Вольт-амперные характеристики транзисторов.
Дата: 2018-12-28, просмотров: 644.