Псевдоморфные полевые транзисторы
с высокой подвижностью 2 D -электронов в канале ( pHEMT )
Курсовая работа
Выполнила:
студентка 4 курса
физико-технического факультета
гр.21401
Якушева Юлия Викторовна
Научный руководитель:
профессор, д.ф-м.н.,
Гуртов Валерий Алексеевич
Петрозаводск 2007
СОДЕРЖАНИЕ
Введение
Глава 1. Псевдоморфные полевые транзисторы с высокой подвижностью 2D-электронов в канале (pHEMT)
1.1 Структура и классификация транзисторов HEMT и pHEMT.
1.2 Приборные параметры pHEMT транзисторов
Глава 2. Анализ физических процессов в HEMT транзисторах
2.1 Концентрация электронов в канале HEMT транзисторов
2.1.1 Уравнение Шредингера для 2D-электронов
2.1.2 Плотность состояний в двумерной подзоне
2.1.3 Расчет концентрации n(z) с учетом квантования
2.1.4 Спектр энергий и вид волновых функций
Глава 3. Вольтамперные характеристики HEMT транзисторов
3.1 Механизм рассеяние горячих носителей
3.2 ВАХ в линейной области
3.3 ВАХ в области насыщения
3.3.1 Напряжение насыщения и ток насыщения
3.3.2 Эффект модуляции длины каналы в области насыщения
3.3.3. Алгоритм расчета ВАХ pHEMT транзистора
3.4. Расчет порогового напряжения pHEMT транзистора
3.5 Расчет концентрации 2D-носителей в канале с учетом заполнения четырех квантовых уровней
Глава 4. Разработка флеш-анимаций, иллюстрирующих физические процессы в HEMT транзисторах
4.1. Программные средства для флеш-анимации
4.2 Реализация флеш-анимаций HEMT транзисторов
Выводы
Список литературы
Введение
Электронный учебник Гуртова В.А. «Твердотельная электроника» впервые был разработан на кафедре физики твердого тела ПетрГУ в 2003 году. В учебном пособии рассматриваются основные типы полупроводниковых приборов и физические процессы, обеспечивающие их работу. Приводится анализ электронных процессов в объеме полупроводников, в электронно-дырочных переходах и в области пространственного заряда на поверхности полупроводников. Подробно представлены характеристики диодов, транзисторов, тиристоров.
Это современный дистанционный учебный курс, содержащий лекции по твердотельной электронике, с развитой системой гиперссылок, контроля и самоконтроля, с помощью которой можно оценить свои знания по изученному материалу. Также в этом учебном курсе есть ссылки на ресурсы сети Интернет и список нужной литературы. Учебник разработан под сетевой вариант.
В связи с тем, что твердотельная электроника является быстро развивающейся отраслью науки, особенно в области практического применения, требуется проводить модернизацию данного курса.
В 2005 году учебник был дополнен главами, посвященными лавинно-пролетным диодам, светодиодам, полупроводниковым лазерам и фотоприемникам, как на основе кремния, так и на перспективных материалах GaAs, GaN, SiC. Рассмотрены квантовый эффект Холла, микроминиатюризация и приборы наноэлектроники, характеристики полупроводниковых приборов при экстремальных температурах.
В настоящее время появилась необходимость в дополнительном включении разделов посвященных псевдоморфным полевым транзисторам
с высокой подвижностью 2D-электронов в канале (pHEMT).
Цель курсовой работы заключалась в изучении и анализе физических процессов, протекающих в транзисторах с высокой подвижностью электронов (HEMT), и разработке флеш-анимации, иллюстрирующих их работу.
Для достижения указанной цели решались следующие задачи:
1. Подбор статей из зарубежных и российских научных журналов, в которых излагаются физические основы работы HEMT транзисторов.
2. Анализ физических процессов, обуславливающих работу HEMT транзисторов.
3. Расчет значение характерных параметров (энергетических уровней 2D-электронов в канале, зависимость энергии Ферми от концентрации электронов в потенциальной яме, пороговое напряжение и ток насыщения).
4. Разработать две флеш-анимации, иллюстрирующие изменение зонной диаграммы и динамику ВАХ HEMT транзистора при изменении напряжения на затворе.
ВАХ в линейной области
Математическое описание ВАХ AlGaAs/InGaAs/GaAs псевдоморфного транзистора с высокой подвижностью электронов (pHEMT). Для описания модели ВАХ сделаны следующие предположения для AlGaAs/InGaAs/GaAs pHEMT:
· постепенное приближение канала;
· как только происходит насыщение скорости около стока в конце канала, ток стока начинает увеличиваться только благодаря модуляции длины канала;
· двухкусочная аппроксимация используется, чтобы представить отношение между скоростью и электрическим полем.
ВАХ AlGaAs/InGaAs/GaAs pHEMT получена для случая, когда сопротивление источника и сопротивление стока предполагают равным нолю. Кривая ВАХ имеет две области: линейную область (VDS <VDSAT) и область насыщенности (VDS> VDSAT).
Рассмотрим линейную область. Ток стока в линейной области записывается:

| (3.8) |
где q – заряд электрона, ns=2D электронный газ, w - длина канала и v – скорость электрона. Скорость, с которой 2DEG электроны перемещаются в канале InGaAs, определяется электрическим полем в канале и подвижностью электронов. Однако если электрическое поле превышает некоторое критическое значение - Ec, в этом случае скорость достигает насыщения. Зависимость v(E) можно представить следующим образом:
 для для  , для , для 
| (3.9) |
где E - продольная составляющая электрического поля, μ – подвижность электронов,  - скорость насыщения и
- скорость насыщения и  - критическое значение электрического поля.
- критическое значение электрического поля.
Вторая особенность при описании ВАХ HEMT транзистора заключается в зависимости концентрации носителей в канале HEMT в неравновесных условиях при приложении напряжения к затвору.
Из уравнения Пуассона для p-типа:

| (3.10) |
при интегрировании от области истощения E=0 до E следует, что

| (3.11) |
где d – толщина узкозонного полупроводника GaAs и E(d)=0. При достаточно малых d и NA, получаем связь электрического поля и концентрации носителей:

| (3.12) |
Исходя из физических соображений и согласно рисунку:
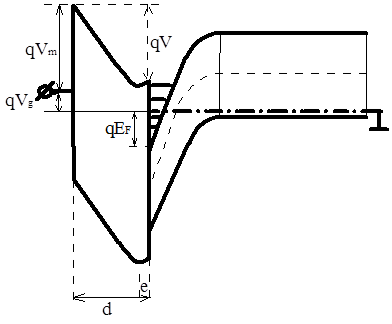
Рис.9 AlGaAs/GaAs гетеростуктура.
мы можем записать зависимость концентрации носителей в канале HEMT при приложении напряжения к затвору в виде:

| (3.13) |
так как  , то отсюда следует:
, то отсюда следует:

| (3.14) |
или

| (3.15) |
здесь Ef – это уровень Ферми относительно дна зоны проводимости в канале и является функцией концентрации носителей на поверхности ns в канале, d2 – это полная толщина слоя AlGaAs, ∆Ec – неоднородность зоны проводимости в гетероструктуре и φb – высота барьера (затвора) Шоттки.

Рис.10 Зависимость концентрации носителей заряда от приложенного напряжения на затвор при температуре 300К: прямая – точное значение, а точечная кривая – Das Gupta.
Для моделирования ВАХ по модели Das Gupta предлагается записать зависимость Ef псевдоморфного транзистора AlGaAs/InGaAs/GaAs (pHEMT) от ns в виде полинома:
| EF=K1+K2ns1/2+K3ns, | (3.16) |
значение Ef рассчитано для трех значений ns, а именно 2 × 1010, 2 × 1011 и 2 × 1012 /см. После замены значений Ef в выражении, стоящем выше, и решения системы из трех уравнений, можно оценить значения коэффициентов К1, К2, К3. Тогда в системе AlGaAs/GaAs, ns запишется как:

| (3.17) |
Преобразуя это выражение, мы получим квадратичное уравнение относительно ns1/2 :
| K4ns+K2ns1/2−(Vg−VT−K1)=0, | (3.18) |
где  . Решение данного уравнения может быть записано в виде:
. Решение данного уравнения может быть записано в виде:

| (3.19) |
Оно обеспечивает отношение для ns в 2-хмерном газе (2-DEG) как функцию напряжения на затворе. В случае напряжения канала V(x) из-за присутствия Vd (напряжения на стоке) выражение для ns запишется:

| (3.20) |
где Vg1=Vg−VT−K1.
Подставляя уравнение (3.8) в (3.9), ток стока в линейной области выражается:

| (3.21) |
Заменяя E = dV / dx в уравнении (3.32) и преобразуя, мы получаем:

| (3.22) |
Интегрируя это уравнение от источника (x=0, V=0) до стока (x=L, V=Vd), мы получаем:

| (3.23) |
ток стока Id может бить записан как:

| (3.24) |
где  и
и  .
.
Подставляя величину ns из уравнения (3.20) в уравнение выше (3.24) и преобразуя, получаем:

| (3.25) |
После интегрирования:

| (3.26) |
где  и
и  .
.
ВАХ в области насыщения
Для создания flash – анимации, иллюстрирующих принцип действия транзистора, иллюстрирующий его зонную диаграмму и структуру (изменение концентрации носителей в потенциальной яме при приложении напряжения и вывод их ВАХ), я воспользовалась программой Flash MX 2004 компании Macromedia. Данная программа позволяет создавать графические изображения, редактировать объекты, работать с текстом, слоями и анимацией; также использовать символы, создавать и применять кнопки, использовать интерактивные элементы, публиковать фильмы Flash и добавлять в них звуки. При изучении Flash MX можно познакомится также с элементами языка сценариев ActionScript. Анимация позволяет сделать исследуемое явление наглядным, а значит более доступным для понимания.
Было рассчитано значение энергетических уровней в потенциальной яме, построен график зависимости уровня Ферми от концентрации электронов в потенциальной яме и показано, что эта зависимость и аппроксимальная кривая DasGupta практически совпадают, те можно утверждать, что нелинейная модель, предложенная DasGupta, является вполне подходящей для аналитической модели pHEMTs AlGaAs/InGaAs/GaAs.
3. Созданиы flash – анимации, иллюстрирующие изменение концентрации носителей в потенциальной яме при приложении напряжения и демонстрация их ВАХ.
Список литературы :
1. Remashan K. A compact analytical I–V model of AlGaAs/InGaAs/GaAs p-HEMTs based on non-linear charge control model / K. Remashan and K. Radhakrishnan // Microelectronic Engineering, Volume 75, Issue 2, August 2004. - p. 127-241.
2. Chia-Shih Cheng. A modified Angelov model for InGaP/InGaAs enhancement- and depletion-mode pHEMTs using symbolic defined device technology / Chia-Shih Cheng, Yuan-Jui Shih, Hsien-Chin Chiu // Solid-State Electronics, Volume 50, Issue 2, February 2006. - p. 254-258.
3. Soetedjo H. Current–voltage behavior of AlGaAs/InGaAs pHEMT structures and the effect of optical illumination / H. Soetedjo, O. Mohd Nizam, Idris Sabtu, J. Mohd Sazli, Ashaari Yusof, Y. Mohd Razman, A.F. Awang Mat //Microelectronics Journal, Volume 37, Issue 6 , June 2006. - p. 480-482.
4. Yahyazadeha R. The effects of depletion layer on negative differential conductivity in AlGaN/GaN high electron mobility transistor / R. Yahyazadeha, A. Asgarib, M. Kalafib // Physica E: Low-dimensional Systems and Nanostructures, Volume 33, Issue 1, June 2006 - p. 77-82.
5. Delagebeaudeuf D. Metal – (n)AlGaAs-(p)GaAs Two-Dimensional Electron Gas FET / D. Delagebeaudeuf, N.T. Linh. //IEEE Transactions on Electron Devices ED-29 , (1982). - p. 955–960.
6. DasGupta N. An analytical expression for sheet carrier concentration vs gate voltage for HEMT modeling / N. DasGupta, A. DasGupta //Solid State Electronics № 36 (1993). - p. 201–203.
7. Chen J. Optimization of gate-to-drain separation in submicron gate-length modulation doped FET’s for maximum power gain performance / J. Chen, M. Thurairaj and M.B. Das //IEEE Transactions on Electron Devices № 41 (1994). - p. 465–475.
8. P. Chao DC and microwave characteristics of sub-0.1 µ-m gate-length planar-doped pseudomorphic HEMT’s / P.Chao, M.S.Shur, R.C.Tiberio, K.H.George Duh, P.M.Smith, J.M.Ballingall, P.Ho and A.A.Jabra. // IEEE Transactions on Electron Devices № 36 (1989). - p. 461–473.
9. Шахнович И. Твердотельные СВЧ-приборы и технологии: состояние и перспективы.// Электроника: Наука, Технология, Бизнес №5,2005 – С. 58-61.
10. Zee S.M. Physics of semiconductors devices / S.M. Zee, Kwok K.Ng.-3-rd edition. - Canada.: A John Willey and sons, inc., 2007. – p. 401-412.
Псевдоморфные полевые транзисторы
с высокой подвижностью 2 D -электронов в канале ( pHEMT )
Курсовая работа
Выполнила:
студентка 4 курса
физико-технического факультета
гр.21401
Якушева Юлия Викторовна
Научный руководитель:
профессор, д.ф-м.н.,
Гуртов Валерий Алексеевич
Петрозаводск 2007
СОДЕРЖАНИЕ
Введение
Дата: 2019-12-22, просмотров: 423.