Наибольшее распространение в современной микроэлектронике получили структуры Me-SiO2-Si (металл – термическая двуокись кремния – кремний).
Разность работ выхода. В реальных МДП структурах разность работ выхода металла Фm и полупроводника ФS, как правило, не равна нулю. Тогда между полупроводником и металлом возникает контактная разность потенциалов. В этом случае и при U=0 существует начальный изгиб зон на границе диэлектрик – полупроводник. Режим плоских зон осуществляется при приложении внешнего смещения, равного
 . (30)
. (30)
Вольтфарадные характеристики МДП структур с  будут сдвинуты вдоль оси напряжений на величину
будут сдвинуты вдоль оси напряжений на величину  .
.
Величина работ выхода различных металлов составляют от 3 до 5 эВ, кремния – от 4.2 до 5.1 эВ в зависимости от уровня легирования и типа проводимости. Соответственно этому значению  могут меняться от -2.1 до +0.8 эВ.
могут меняться от -2.1 до +0.8 эВ.
Используя в качестве электрода различные металлы, а, также изменяя уровень легирования кремния, можно изменять состояние поверхности кремния от обогащения до инверсии.
Заряд в диэлектрике и на границе диэлектрик – полупроводник. В реальных МДП структурах в слое диэлектрика и на границе «диэлектрик – полупроводник» имеются заряды различной природы. Так, вблизи границы диэлектрик – полупроводник в области протяженностью порядка десяти нанометров существует положительный фиксированный заряд, не изменяющийся при приложении постоянного внешнего смещения, плотность которого слабо зависит от толщины диэлектрика, типа проводимости и уровня легирования полупроводника. Величина плотности фиксированного заряд Qf определяется условиями получения и отжига диэлектрика.
Фиксированный положительный заряд Qf вызывает смещение C- U кривой в область отрицательных напряжений (рис.12), причем величина этого смещения Ufb равна
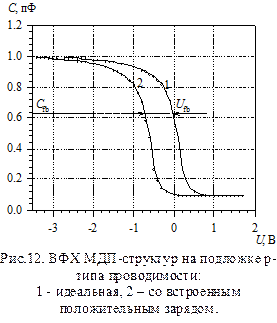
 . (31)
. (31)
Для компенсации влияния положительных ионов необходимо приложить отрицательное внешнее смещение, равное  .
.
В пленках SiO2 содержатся также ионы щелочных металлов (Na+, K+), протоны H+ и кислородные вакансии, способные перемещаться в слое диэлектрика под действием электрического поля при повышенной температуре (150 - 250 °C). В результате миграции подвижных ионов при положительной термополевой обработке (ТПО) МДП структуры ВФХ после смещается относительно исходной ВФХ, что объясняется следующим образом. Вначале щелочные ионы располагаются в SiO2 на ловушках на границе метал–SiO2. При повышенной температуре эти ионы высвобождаются из ловушек и под действием положительного смещения передвигаются к границе диэлектрик– SiO2, что приводит к изменению поверхностного потенциала  и, соответственно, смещение ВФХ на величину
и, соответственно, смещение ВФХ на величину  .
.
Поверхностные состояния. В реальных МДП структурах на границе диэлектрик–полупроводник существуют поверхностные состояния (ПС) – энергетические уровни в запрещенной зоне полупроводника, способные обмениваться носителями заряда с разрешенными энергетическими зонами. Наличие поверхностных состояний обусловлено нарушением периодичности потенциала кристалла на поверхности полупроводника. Реальная поверхность кремния всегда покрыта тонким слоем окисла SiO2. При этом плотность состояний на границе окисел – полупроводник составляет »1∙1012 см-2. Плотность ПС пропорциональна плотности атомов на поверхности Si и зависит от ориентации пластины полупроводника.
На границе SiO2–n-Si в запрещенной зоне Si имеются ПС акцепторного типа, которые заряжаются отрицательно при заполнении электронами и становятся нейтральными при возбуждении электронов с ПС в зону проводимости. В системе SiO2 – кремний р – типа в запрещенной зоне имеются ПС донорного типа. ПС заряжены положительно при заполнении дырками и нейтральны при возбуждении дырок с ПС в валентную зону.
При изменении поверхностного потенциала  положение поверхностных уровней изменяется относительно уровня Ферми, а, следовательно, изменяется и заряд поверхностных состояний QSC.
положение поверхностных уровней изменяется относительно уровня Ферми, а, следовательно, изменяется и заряд поверхностных состояний QSC.
Экспериментально установлено, что для системы Si-SiO2 максимальная плотность поверхностных состояний соответствует областям запрещенной зоны, примыкающим к ЕС и EV. Вблизи середины запрещенной зоны плотность состояний обычно не превышает значения 1·1011 см-2эВ-1.
Итак, сдвиг ВФХ реальной МДП структуры относительно ВФХ идеальной МДП структуры определяется зарядом поверхностных состояний  , зарядами в диэлектрике Qf и Qm и разностью работ выхода
, зарядами в диэлектрике Qf и Qm и разностью работ выхода  .
.
Если известно распределение заряда по толщине по толщине r(x) (координата x отсчитывается от границы металл–диэлектрик) то эффективную плотность заряда на границе диэлектрик-полупроводник можно рассчитать по следующей формуле.
 . (32)
. (32)
Тогда напряжение смещения, соответствующее режиму плоских зон, будет определяться соотношением
 . (33)
. (33)
Напряжение  называется напряжением плоских зон. Отметим, что для идеальных МДП структур
называется напряжением плоских зон. Отметим, что для идеальных МДП структур  =0.
=0.
Дата: 2019-12-10, просмотров: 357.