Определение многих параметров полупроводниковых материалов основано на измерении зависимости емкости какого-либо элемента от приложенного к нему напряжения, то есть на измерении вольтфарадных характеристик. Такие измерения дают возможность быстрого определения основных параметров полупроводниковых и диэлектрических слоев.
Измерение емкости может быть реализовано различными способами: методом R-C-делителя, методом C-C делителя, мостовым способом, резонансным методом и др.
Рассмотрим два часто используемых метода.
1) Метод R- C-делителя.
Схема, реализующая метод R-C-делителя представлена на рис.1.
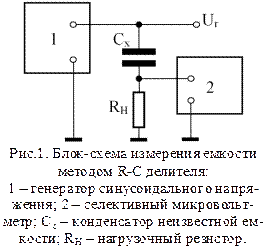 Источником сигнала является генератор 1 с частотой синусоидального напряжения f. Падение напряжения на нагрузочном резисторе RН, связано с напряжением на выходе генератора UГ и величиной емкости Cx соотношением:
Источником сигнала является генератор 1 с частотой синусоидального напряжения f. Падение напряжения на нагрузочном резисторе RН, связано с напряжением на выходе генератора UГ и величиной емкости Cx соотношением:
 , (1)
, (1)
где ω – круговая частота переменного напряжения на выходе генератора.
Если  , то формула (1) преобразуется к следующему виду.
, то формула (1) преобразуется к следующему виду.
 , (2)
, (2)
откуда можно записать выражение для неизвестной емкости Cx
 . (3)
. (3)
На рис.2 представлены расчетные зависимости UН от значения измеряемой емкости Cx (f=100 кГц, 1: RН=100 Ом, f=8кГц и 2: RН=50 Ом). Сплошными линиями показаны кривые, рассчитанные по формуле (1), пунктиром – по формуле (3). По этим графикам возможно оценить точность определения емкости.
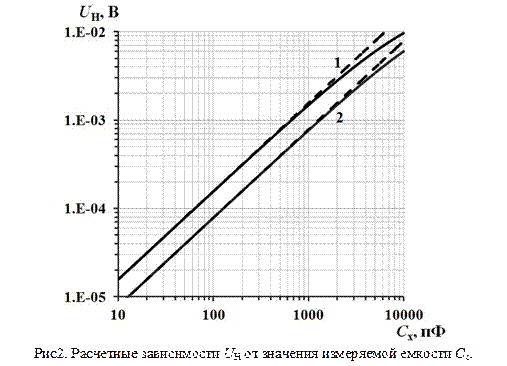
Недостатком схемы R-C-делителя является необходимость в каждом случае учитывать зависимости, показанные на рис.2.
2) Метод моста переменного тока.
Мостовые схемы переменного тока работают как пара двухкомпонентных делителей напряжения присоединённых параллельно к источнику переменного напряжения, а индикатор нулевого сигнала (обычно – резонансный усилитель) включён в диагональ моста для установки баланса моста при минимальном сигнале.
Применяемая в мостовом методе схема для измерения емкости (мост Вина) представлена на рис.4. Балансировка моста Вина производится изменением емкости переменного конденсатора CЭ и сопротивления переменного резистора RЭ до минимальных показаний на селективного микровольтметра.
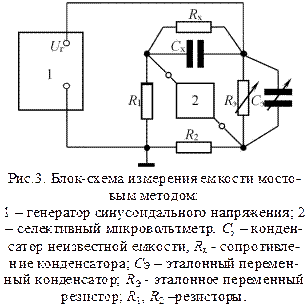 При балансе моста между элементами схемы будет выполняться соотношение
При балансе моста между элементами схемы будет выполняться соотношение
 (4)
(4)
где  ,
,  ,
,  ,
,  .
.
При изменении емкости эталонного переменного конденсатора CЭ и сопротивления эталонного переменного резистора RЭ регулируется амплитуда и фаза сигнала до тех пор, пока мост не сбалансируется. После баланса моста значения RЭ и CЭ определяются по их шкалам, вычисляется параллельный импеданс, а неизвестные ёмкость Cx и сопротивление Rx вычисляются из уравнения (4). При работе с таким мостом предполагается, что эталонный конденсатор имеет пренебрежительно малое внутреннее сопротивление.
В электрофизике полупроводников необходимо измерять не просто емкость, а зависимость дифференциальной емкости двухполюсника от приложенного к нему внешнего напряжения, то есть измерять вольтфарадную характеристику (ВФХ) двухполюсника. Таким образом схемы для измерения ВФХ должны обеспечивать развязку цепи постоянного тока от цепи переменного тока. Объектами измерения ВФХ являются разнообразные полупроводниковые структуры и приборы, в частности, p-n переходы и полупроводниковые приборы на их основе, контакты металл-полупроводник и приборы на их основе конденсаторы металл-диэлектрик-полупроводник и приборы на их основе.
На рис.4 представлена блок-схема установки измерения ВФХ на основе метода R-C-делителя.
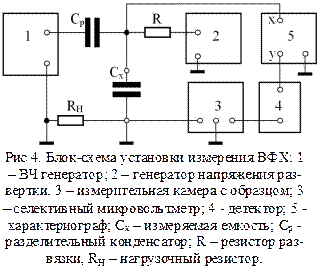 Высокочастотный сигнал (f=100 кГц – 1 Мгц, UM=25 мВ) через разделительный конденсатор Ср поступает на цепочку, состоящую из измеряемой зависящей от приложенного напряжения емкости Сx (Ср>>Сx) и эталонного нагрузочного резистора RН (RН=50 – 100 Ом). Также к емкости Сx через резистор развязки R прикладывается постоянное напряжение развертки (линейно или ступенчато изменяющееся) с генератора 2. Падение переменного напряжения на RН пропорционально емкости Сx, если удовлетворяется условие
Высокочастотный сигнал (f=100 кГц – 1 Мгц, UM=25 мВ) через разделительный конденсатор Ср поступает на цепочку, состоящую из измеряемой зависящей от приложенного напряжения емкости Сx (Ср>>Сx) и эталонного нагрузочного резистора RН (RН=50 – 100 Ом). Также к емкости Сx через резистор развязки R прикладывается постоянное напряжение развертки (линейно или ступенчато изменяющееся) с генератора 2. Падение переменного напряжения на RН пропорционально емкости Сx, если удовлетворяется условие  . Переменное падение напряжения с резистора RН поступает на селективный микровольтметр (резонансный усилитель) 3, затем на детектор 4 и на регистрирующее устройство, например, канал «y» характериографа, например, двухкоординатного графопостроителя 5.
. Переменное падение напряжения с резистора RН поступает на селективный микровольтметр (резонансный усилитель) 3, затем на детектор 4 и на регистрирующее устройство, например, канал «y» характериографа, например, двухкоординатного графопостроителя 5.
Пример схемы, реализующей метод не полностью сбалансированного R-C моста представлен на рис.5.
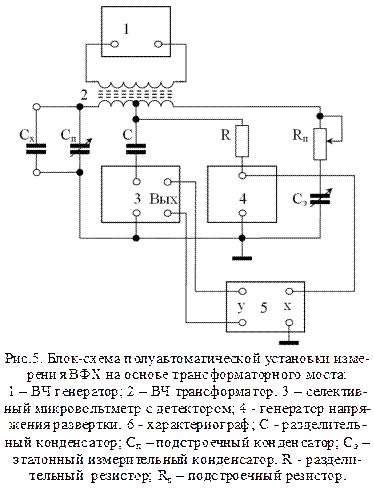 Высокочастотный сигнал (f=1 Мгц, U=25 мВ≈φT.) с генератора 1 через трансформатор 2 поступает на мостовую схему, в левое плечо которой состоит из включенных параллельно конденсатора Cп и емкости структуры Cx, а правое плечо - из последовательно включенных эталонного конденсатора Cэ и подстроечного резистора Rп. Через резистор R к МДП структуре прикладывается напряжение развертки с генератора 4. Переменное напряжение разбаланса моста, пропорциональное Cx, поступает на селективный микровольтметр 5 с встроенным на выходе детектором. С выхода микровольтметра 5 постоянное напряжение пропорциональное Cx, подается на вход «y» характериографа 6, а на его на вход «x» подается напряжение с выхода генератора 4.
Высокочастотный сигнал (f=1 Мгц, U=25 мВ≈φT.) с генератора 1 через трансформатор 2 поступает на мостовую схему, в левое плечо которой состоит из включенных параллельно конденсатора Cп и емкости структуры Cx, а правое плечо - из последовательно включенных эталонного конденсатора Cэ и подстроечного резистора Rп. Через резистор R к МДП структуре прикладывается напряжение развертки с генератора 4. Переменное напряжение разбаланса моста, пропорциональное Cx, поступает на селективный микровольтметр 5 с встроенным на выходе детектором. С выхода микровольтметра 5 постоянное напряжение пропорциональное Cx, подается на вход «y» характериографа 6, а на его на вход «x» подается напряжение с выхода генератора 4.
Для различных объектов измерения используются разные методы измерения емкости. В настоящее время наиболее широко используемый метод измерения ВФХ это рассмотренный выше мостовой метод измерения на переменном токе.
 Общая упрощенная схема измерений ВФХ методом представлена па рисунке 6.
Общая упрощенная схема измерений ВФХ методом представлена па рисунке 6.
Измерение переменного тока и напряжения па тестируемом образце, а также фазового сдвига между ними, происходит, обычно, мостовым методом с автобалансировкой и позволяет определить полный комплексный импеданс тестируемой структуры.
Тестируемый двухполюсник Zx, представленный в виде параллельного соединения измеряемых емкости Cx и проводимости Gx подключается к измерителю 1 (мосту переменного тока с автобалансировкой) по четырехпроводной схеме (U, U•, I, I•)для исключения влияния сопротивления кабелей.
Мост переменного тока содержит измеритель тока 3 и измеритель напряжения 4. На Zx подается небольшое тестовое переменное напряжение (U=25 – 30 мВ, f=10 кГц – 1 МГц) с генератора 2 и постоянное изменяющееся напряжение с генератора 3. Постоянное напряжение в обычных режимах измерения ВФХ МДП структур обычно не превышает ±10 В. Низковольтные источники постоянного напряжения, как правило, встроены в сам измеритель C-V характеристик. При необходимости более высоких постоянных напряжений используют внешние источники напряжения.
Идеальная МДП структура
Для исследования поверхностных явлений используют структуры металл - диэлектрик - полупроводник (МДП). Эти структуры являются составной частью МДП транзисторов, являющихся основой современных планарных приборов и интегральных схем большой и сверхбольшой степени интеграции.
 Простейшая МДП структура (рис.7) состоит из полупроводниковой подложки толщиной 300 – 800 мкм и достаточно тонкого слоя диэлектрика, на котором формируется управляющий полевой электрод (затвор) из металла или высоколегированного поликристаллического кремния.
Простейшая МДП структура (рис.7) состоит из полупроводниковой подложки толщиной 300 – 800 мкм и достаточно тонкого слоя диэлектрика, на котором формируется управляющий полевой электрод (затвор) из металла или высоколегированного поликристаллического кремния.
Толщина слоя подзатворного диэлектрика в зависимости от цели исследования может составлять от 3 – 100 нм (подзатворный диэлектрик МДП транзисторов в кремниевых БИС и СБИС) до 1 мкм.
С обратной стороны пластины создается омический контакт к полупроводнику. В дальнейшем будем предполагать подложку заземленной, а потенциал U отсчитывать относительно потенциала подложки, равного нулю.
Основой понимания свойств реальных МДП структур является теория идеальной МДП структуры, для которой выполняются следующие условия:
1) разность термодинамических работ выхода металла Φ m и полупроводника Φ s равна нулю: Φ ms=Φ m-Φ s=0;
2) при внешнем смещении возникают заряд на управляющем электроде и равный ему заряд противоположного знака в приповерхностной области полупроводника. Заряд в диэлектрике отсутствует;
3) сопротивление диэлектрика бесконечно велико (идеальный диэлектрик).
4) Суммарное сопротивление подложки и омического контакта RS=0.
Энергетическая зонная диаграмма идеальной МДП структуры на подложке n-типа при нулевом внешнем смещении изображена на рис. 8.
 В состоянии термодинамического равновесия уровень Ферми в МДП структуре всюду одинаков. Внешняя работа выхода (электронное средство)
В состоянии термодинамического равновесия уровень Ферми в МДП структуре всюду одинаков. Внешняя работа выхода (электронное средство)  определяется как минимальная работа, необходимая для того, чтобы переместить электрон, находящийся на дне зоны проводимости на поверхности полупроводника, в вакуум:
определяется как минимальная работа, необходимая для того, чтобы переместить электрон, находящийся на дне зоны проводимости на поверхности полупроводника, в вакуум:
 , (5)
, (5)
где E0 – энергия покоящегося электрона в вакууме.
Термодинамическая работа выхода из полупроводника  зависит от положения уровня Ферми и определяется равенством
зависит от положения уровня Ферми и определяется равенством
 , (6)
, (6)
где  ;
;  - ширина запрещенной зоны, Еi – энергия, соответствующая середине запрещенной зоны.
- ширина запрещенной зоны, Еi – энергия, соответствующая середине запрещенной зоны.
Поскольку в идеальной МДП структуре Φm=Φs и нет заряда в диэлектрике, то при нулевом внешнем смещении (U=0) нет изгиба энергетических зон - режим плоских зон. (рис.8 и 9,а)
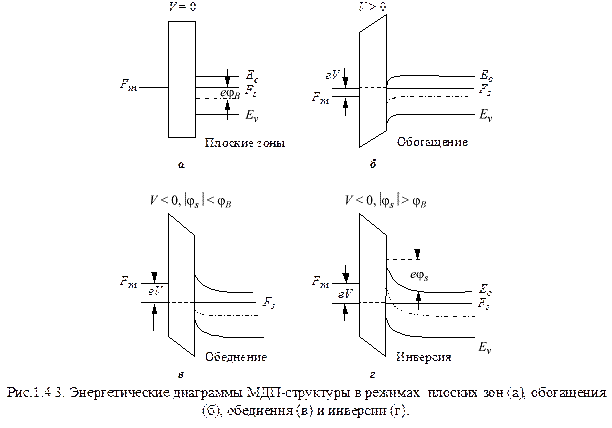
При приложении смещения U к управляющему электроду в полупроводнике возникает электрическое поле. При этом электроны и дырки приобретают дополнительную потенциальную энергию. Величина этой энергии равна  для электронов и
для электронов и  для дырок, где
для дырок, где  - электрический потенциал в точке х.
- электрический потенциал в точке х.
Энергия электрона на дне зоны проводимости теперь равна  и является функцией координаты х. Учитывая, что отсчет энергии для дырок ведется вниз, величина энергии дырки на уровне ЕV равна
и является функцией координаты х. Учитывая, что отсчет энергии для дырок ведется вниз, величина энергии дырки на уровне ЕV равна  .
.
Изменение энергии электронов и дырок под действием внешнего поля соответствует появлению изгиба зон на энергетической диаграмме в области, где потенциал  отличен от нуля. В объеме полупроводника
отличен от нуля. В объеме полупроводника  и концентрация электронов и дырок остаются равновесными: n0 и p0, соответственно. В невырожденном полупроводнике они рваны
и концентрация электронов и дырок остаются равновесными: n0 и p0, соответственно. В невырожденном полупроводнике они рваны
 , (7)
, (7)
 , (8)
, (8)
где NC и NV – эффективные плотности состояний соответственно в зоне проводимости и валентной зоне.
В приповерхностной области, где  , концентрации электронов и дырок определяются выражениями:
, концентрации электронов и дырок определяются выражениями:
 , (9)
, (9)
 , (10)
, (10)
где  .
.
При положительном смещении (U>0) электроны в полупроводнике притягиваются к границе диэлектрик–полупроводник, экранируя объем полупроводника от проникновения поля. В полупроводнике вблизи границы диэлектрик - полупроводник образуется область, обогащенная основными носителями электронами (концентрация электронов на поверхности nS больше, чем в объеме n0). Этот режим называется режимом обогащения (рис. 9,б). Толщина обогащенной области - не более нескольких десятков ангстрем. Плотность заряда электронов на единицу площади в этой области Qsc равна по величине и обратна по знаку плотности заряда на управляющем электроде Qm.
Если к структуре прикладывается отрицательное смещение (U<0), зоны изгибаются вверх. При этом в приповерхностной области концентрация электронов меньше, чем в объеме. Вблизи поверхности образуется область пространственного заряда (ОПЗ), обедненная электронами. Ее объемный положительный заряд обусловлен, главным образом, зарядом ионизированных донорных атомов. Этот режим называется режимом обеднения (рис.9,в). Отметим, что протяженность области обеднения W значительно больше, чем области, содержащей избыточный отрицательный заряд в режиме обогащения при одинаковых по абсолютной величине внешних смещениях. Заряд на единицу площади при обеднении равен  , где ND – концентрация ионизированных ионов примеси.
, где ND – концентрация ионизированных ионов примеси.
Величина W определяется уровнем легирования полупроводника и приложенным смещением и может составлять несколько микрометров.
Если к образцу приложить большое отрицательное смещение, изгиб зон становится так велик, что уровень Ферми на границе раздела диэлектрик – полупроводник совпадает с серединой запрещенной зоны – уровнем Ei. При этом концентрации электронов и дырок на поверхности становятся одинаковыми, как в собственном полупроводнике. При еще больших отрицательных смещениях уровень Ферми на поверхности располагается ниже уровня Ei. При этом концентрация неосновных носителей (дырок) на поверхности больше, чем основных. Такой режим называется режимом инверсии (рис.9,г).
В режиме инверсии QSC в ОПЗ также положителен и обусловлен как зарядом ионизированных доноров QD, так и зарядом Qp неосновных носителей (дырок): QSC = QD+Qp.
Таким образом, изменяя величину и полярность смещения на управляющем электроде, можно изменять концентрацию носителей в приповерхностной области полупроводника.
Дата: 2019-12-10, просмотров: 475.