Продолжительность.
Работа продолжается четыре академических часа.
Оборудование, приборы, инструментарий.
Персональный компьютер с прикладным программным обеспечением, хранящимся на жестком диске; измеритель L,C,R Agilent 4284A; устройство зондовое, содержащее микроскоп МБС-9, контактный стол, два зондодержателя с зондами; форвакуумный насос Измеритель L,C,R управляется через интерфейс PCI – GPIB; кассеты с измеряемыми пластинами; пинцет. Измеритель L,C,R управляется через интерфейс PCI – GPIB
Теория.
Идеальная МДП структура
Для исследования поверхностных явлений используют структуры металл - диэлектрик - полупроводник (МДП). Эти структуры являются составной частью МДП транзисторов, являющихся основой современных планарных приборов и интегральных схем большой и сверхбольшой степени интеграции.
 Простейшая МДП структура (рис.7) состоит из полупроводниковой подложки толщиной 300 – 800 мкм и достаточно тонкого слоя диэлектрика, на котором формируется управляющий полевой электрод (затвор) из металла или высоколегированного поликристаллического кремния.
Простейшая МДП структура (рис.7) состоит из полупроводниковой подложки толщиной 300 – 800 мкм и достаточно тонкого слоя диэлектрика, на котором формируется управляющий полевой электрод (затвор) из металла или высоколегированного поликристаллического кремния.
Толщина слоя подзатворного диэлектрика в зависимости от цели исследования может составлять от 3 – 100 нм (подзатворный диэлектрик МДП транзисторов в кремниевых БИС и СБИС) до 1 мкм.
С обратной стороны пластины создается омический контакт к полупроводнику. В дальнейшем будем предполагать подложку заземленной, а потенциал U отсчитывать относительно потенциала подложки, равного нулю.
Основой понимания свойств реальных МДП структур является теория идеальной МДП структуры, для которой выполняются следующие условия:
1) разность термодинамических работ выхода металла Φ m и полупроводника Φ s равна нулю: Φ ms=Φ m-Φ s=0;
2) при внешнем смещении возникают заряд на управляющем электроде и равный ему заряд противоположного знака в приповерхностной области полупроводника. Заряд в диэлектрике отсутствует;
3) сопротивление диэлектрика бесконечно велико (идеальный диэлектрик).
4) Суммарное сопротивление подложки и омического контакта RS=0.
Энергетическая зонная диаграмма идеальной МДП структуры на подложке n-типа при нулевом внешнем смещении изображена на рис. 8.
 В состоянии термодинамического равновесия уровень Ферми в МДП структуре всюду одинаков. Внешняя работа выхода (электронное средство)
В состоянии термодинамического равновесия уровень Ферми в МДП структуре всюду одинаков. Внешняя работа выхода (электронное средство)  определяется как минимальная работа, необходимая для того, чтобы переместить электрон, находящийся на дне зоны проводимости на поверхности полупроводника, в вакуум:
определяется как минимальная работа, необходимая для того, чтобы переместить электрон, находящийся на дне зоны проводимости на поверхности полупроводника, в вакуум:
 , (5)
, (5)
где E0 – энергия покоящегося электрона в вакууме.
Термодинамическая работа выхода из полупроводника  зависит от положения уровня Ферми и определяется равенством
зависит от положения уровня Ферми и определяется равенством
 , (6)
, (6)
где  ;
;  - ширина запрещенной зоны, Еi – энергия, соответствующая середине запрещенной зоны.
- ширина запрещенной зоны, Еi – энергия, соответствующая середине запрещенной зоны.
Поскольку в идеальной МДП структуре Φm=Φs и нет заряда в диэлектрике, то при нулевом внешнем смещении (U=0) нет изгиба энергетических зон - режим плоских зон. (рис.8 и 9,а)
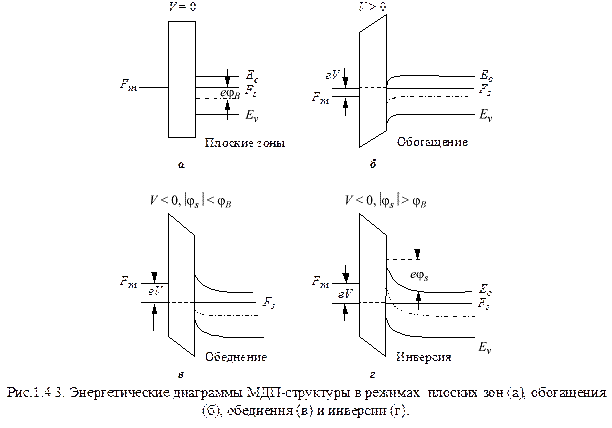
При приложении смещения U к управляющему электроду в полупроводнике возникает электрическое поле. При этом электроны и дырки приобретают дополнительную потенциальную энергию. Величина этой энергии равна  для электронов и
для электронов и  для дырок, где
для дырок, где  - электрический потенциал в точке х.
- электрический потенциал в точке х.
Энергия электрона на дне зоны проводимости теперь равна  и является функцией координаты х. Учитывая, что отсчет энергии для дырок ведется вниз, величина энергии дырки на уровне ЕV равна
и является функцией координаты х. Учитывая, что отсчет энергии для дырок ведется вниз, величина энергии дырки на уровне ЕV равна  .
.
Изменение энергии электронов и дырок под действием внешнего поля соответствует появлению изгиба зон на энергетической диаграмме в области, где потенциал  отличен от нуля. В объеме полупроводника
отличен от нуля. В объеме полупроводника  и концентрация электронов и дырок остаются равновесными: n0 и p0, соответственно. В невырожденном полупроводнике они рваны
и концентрация электронов и дырок остаются равновесными: n0 и p0, соответственно. В невырожденном полупроводнике они рваны
 , (7)
, (7)
 , (8)
, (8)
где NC и NV – эффективные плотности состояний соответственно в зоне проводимости и валентной зоне.
В приповерхностной области, где  , концентрации электронов и дырок определяются выражениями:
, концентрации электронов и дырок определяются выражениями:
 , (9)
, (9)
 , (10)
, (10)
где  .
.
При положительном смещении (U>0) электроны в полупроводнике притягиваются к границе диэлектрик–полупроводник, экранируя объем полупроводника от проникновения поля. В полупроводнике вблизи границы диэлектрик - полупроводник образуется область, обогащенная основными носителями электронами (концентрация электронов на поверхности nS больше, чем в объеме n0). Этот режим называется режимом обогащения (рис. 9,б). Толщина обогащенной области - не более нескольких десятков ангстрем. Плотность заряда электронов на единицу площади в этой области Qsc равна по величине и обратна по знаку плотности заряда на управляющем электроде Qm.
Если к структуре прикладывается отрицательное смещение (U<0), зоны изгибаются вверх. При этом в приповерхностной области концентрация электронов меньше, чем в объеме. Вблизи поверхности образуется область пространственного заряда (ОПЗ), обедненная электронами. Ее объемный положительный заряд обусловлен, главным образом, зарядом ионизированных донорных атомов. Этот режим называется режимом обеднения (рис.9,в). Отметим, что протяженность области обеднения W значительно больше, чем области, содержащей избыточный отрицательный заряд в режиме обогащения при одинаковых по абсолютной величине внешних смещениях. Заряд на единицу площади при обеднении равен  , где ND – концентрация ионизированных ионов примеси.
, где ND – концентрация ионизированных ионов примеси.
Величина W определяется уровнем легирования полупроводника и приложенным смещением и может составлять несколько микрометров.
Если к образцу приложить большое отрицательное смещение, изгиб зон становится так велик, что уровень Ферми на границе раздела диэлектрик – полупроводник совпадает с серединой запрещенной зоны – уровнем Ei. При этом концентрации электронов и дырок на поверхности становятся одинаковыми, как в собственном полупроводнике. При еще больших отрицательных смещениях уровень Ферми на поверхности располагается ниже уровня Ei. При этом концентрация неосновных носителей (дырок) на поверхности больше, чем основных. Такой режим называется режимом инверсии (рис.9,г).
В режиме инверсии QSC в ОПЗ также положителен и обусловлен как зарядом ионизированных доноров QD, так и зарядом Qp неосновных носителей (дырок): QSC = QD+Qp.
Таким образом, изменяя величину и полярность смещения на управляющем электроде, можно изменять концентрацию носителей в приповерхностной области полупроводника.
Характеристик МДП структур
Наиболее распространенным методом определения эффективного заряда в диэлектрике является метод, основанный на измерении ВЧ дифференциальной емкости МДП структуры в зависимости от напряжения, или сокращенно C- V (C- U) – метод. Суть метода заключается в следующем. Экспериментально определяется зависимость емкости С от внешнего смещения V при частоте сигнала 1 МГц так, чтобы вкладом поверхностных состояний в емкость С можно было пренебречь, (состояния не успевают перезаряжаться, CSS=0.
В реальных МДП структурах общий заряд на границе раздела диэлектрик–полупроводник и в диэлектрике обусловлен как ПС, так и зарядами Qf и Qm.
Определить вклад каждого из этих зарядов с помощью C- U метода не удается. Можно лишь найти общую эффективную плотность поверхностного заряда Qef приведенную к границе раздела диэлектрик–полупроводник. В режиме плоских зон заряд Qef равен
 , (34)
, (34)
где  - сдвиг напряжения плоских зон
- сдвиг напряжения плоских зон  для реальной МДП структуры по отношению к идеальной.
для реальной МДП структуры по отношению к идеальной.
Напряжение  для реальной МДП структуры соответствует емкости
для реальной МДП структуры соответствует емкости  , которая рассчитывается с помощью соотношений (14), (23) и (24).
, которая рассчитывается с помощью соотношений (14), (23) и (24).
Экспериментальная часть
Методика измерений
В настоящей работе измерение зависящей от напряжения высокочастотной емкости МДП структуры на автоматизированной установке измерения вольтфарадных характеристик полупроводниковых структур.
Блок-схема макета автоматизированной установки представлена на рис.13.
1 - персональный компьютер (ПК) – управляющая ПЭВМ;
2 - измеритель L,C,R Agilent 4284A;
4 - измерительная камера с устройством зондовым и микроскопом;
5 - форвакуумный насос.
Измерение ВФХ производится на переменном токе частотой 1 МГц и амплитудой 25 мВ. Этот сигнал накладывается на напряжение развертки, которое изменяется от инверсии к обогащению с определенным шагом по напряжению. Максимальный диапазон напряжения развертки от -10 В до +10 В.
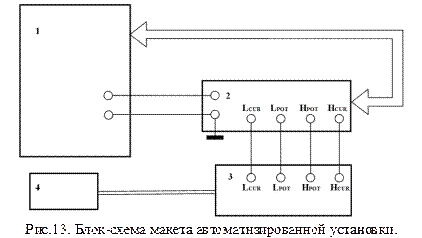
Установка позволяет измерять высокочастотные ВФХ МДП структур в заданных областях на пластине; осуществлять сбор и хранение полученных данных и представлять полученную информацию в графическом и цифровом виде.
Образцы для измерений
Объектом для измерений служат пластины с МОП структурами металл - двуокись-кремния – кремний. SiO2 может иметь толщину от 25 нм до 300 нм, подложки - кремний n- и p-типов проводимости с различным удельным сопротивлением. Поперечное сечение подобной структуры представлено на рис.7.
Расположение полевых электродов и их площади представлены на рис.14.
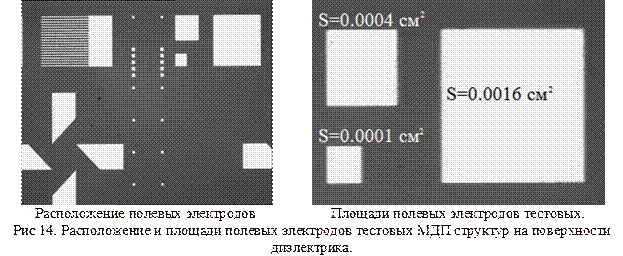
Контакт к подложке такой структуры осуществляется с ее обратной стороны от контактного стола.
Однополюсная вилка на кабеле от контактного стола вставляется в дальнее от измерителя гнездо на устройстве зондовом. Контакт к барьерному электроду осуществляется при помощи зонда, однополюсная вилка от которого вставляется в ближнее к измерителю гнездо на устройстве зондовом. Ближнее гнездо подключено к входам измерителя 4284A HPOT HCUR, дальнее о гнездо подключено к входам измерителя 4284A LPOT LCUR.
Подготовка к проведению измерений.
После составления конспекта описания получите у преподавателя допуск к работе. Проверьте соединение блоков установки по блок-схеме (рис.13) и коммутацию вилок от зонда и от контактного стола.
Включите входящие в состав установки блоки в следующей последовательности.
- Персональный компьютер.
- Измеритель L,C,R Agilent 4284A.
- Форвакуумный насос, обеспечивающий прижатие измеряемой пластины к столику.
Проведение измерений.
1. Откройте крышку измерительной камеры и выдвиньте на себя контактный столик. Включите подсветку микроскопа. Достаньте пластину с МДП структурами из кассеты, установите ее на столик и, смотря в микроскоп, передвиньте столик с пластиной так, чтобы затвор измеряемой МДП структуры располагался под зондом. Откройте кран вакуумной присоски.
2. «Главное меню» ГМ (рис.15) предназначено для выбора одной из опций прикладной программы путем выбора соответствующего меню первого уровня.

3. Запустите на исполнение прикладную измерительную программу измерения ВФХ и расчета параметров МДП структуры. Путь к ярлыку, запускающему ППО измерения ВФХ МДП структур и расчета их параметров: «Рабочий стол \ Лаб. работы \ Методы исследований \CV_MOS \ cv_mos\». После загрузки программы на экране видеомонитора появляется «Главное меню» (рис.15).
4. ГМ предназначено для выбора одной из опций прикладной программы путем выбора соответствующего меню первого уровня.
− Опция «Имитация» - предназначена для проведения виртуальных измерений ВФХ МДП структур.
−  Опция «Результаты» служит для просмотра ранее полученных результатов измерения ВФХ МДП структур, сохраненных на жестком диске в виде файлов данных.
Опция «Результаты» служит для просмотра ранее полученных результатов измерения ВФХ МДП структур, сохраненных на жестком диске в виде файлов данных.
− Опция «Помощь» служит для ознакомления с теорией МПД структур и методикой измерения их ВЧ ВФХ.
− Опция «Измерения» - предназначена для проведения реальных измерений ВФХ МДП структур и расчета их основных параметров.
5. Щелкните левой кнопкой мыши по правой клавише ГМ «Измерения» (рис.15). На экране видеомонитора появится окно меню первого уровня «Измерения» (рис.16).
6. Щелкните левой кнопкой мыши по клавише «Ввод» меню первого уровня «Измерения». На экране видеомонитора появится меню «Ввод» предназначенное для ввода служебной информации, исходных данных об измеряемом образце, режиме измерений (рис.17).
 Введите в соответствующие окна служебную информацию, данные об измеряемом образце и режиме измерений. В окне «Тип проводимости» укажите тип проводимости кремниевой подложки, если он известен: «N» или «P», а если не известен, то введите «A». После ввода данных щелкните левой кнопкой мыши по клавише «OK», после чего окно «Ввод» закроется.
Введите в соответствующие окна служебную информацию, данные об измеряемом образце и режиме измерений. В окне «Тип проводимости» укажите тип проводимости кремниевой подложки, если он известен: «N» или «P», а если не известен, то введите «A». После ввода данных щелкните левой кнопкой мыши по клавише «OK», после чего окно «Ввод» закроется.
7.  Щелкните левой кнопкой мыши по клавише «Измерение» меню первого уровня «Измерения». На экране видеомонитора появится окно «Измерения» предназначенное для запуска и отслеживания процесса измерения ВФХ МДП структуры (рис.18). В верхнем полуокне размещены указания прикладной программы, а в нижнем значения емкости между столом с пластиной и поднятым зондом. Проводить калибровку надо в случае, если величина паразитной емкости, измеряемой измерителем L,C,R Agilent 4284A при поднятом зонде достаточно велика (0.1 пФ и более). Для отказа от калибровки нажмите клавишу «M».
Щелкните левой кнопкой мыши по клавише «Измерение» меню первого уровня «Измерения». На экране видеомонитора появится окно «Измерения» предназначенное для запуска и отслеживания процесса измерения ВФХ МДП структуры (рис.18). В верхнем полуокне размещены указания прикладной программы, а в нижнем значения емкости между столом с пластиной и поднятым зондом. Проводить калибровку надо в случае, если величина паразитной емкости, измеряемой измерителем L,C,R Agilent 4284A при поднятом зонде достаточно велика (0.1 пФ и более). Для отказа от калибровки нажмите клавишу «M».
8.  Окно «Измерения» видоизменится. Выполните указания прикладной программы, расположенные в верхнем полуокне. Опустите зонд на полевой электрод (существенное увеличение отображаемой на экране видеомонитора емкости С указывает на то, что контакт зонда с полевым электродом осуществлен). Закройте крышку измерительной камеры и снова нажмите клавишу «M». В нижнем полуокне будет отображаться процесс измерения ВФХ МДП структуры (рис.19). После индикации одного-двух первых измерений (n=1, n=2) следует обязательно выключить подсветку микроскопа. При необходимости выхода из режима измерения ВФХ МДП структуры нажмите клавишу «Q». По окончании измерений на экране появится ГМ.
Окно «Измерения» видоизменится. Выполните указания прикладной программы, расположенные в верхнем полуокне. Опустите зонд на полевой электрод (существенное увеличение отображаемой на экране видеомонитора емкости С указывает на то, что контакт зонда с полевым электродом осуществлен). Закройте крышку измерительной камеры и снова нажмите клавишу «M». В нижнем полуокне будет отображаться процесс измерения ВФХ МДП структуры (рис.19). После индикации одного-двух первых измерений (n=1, n=2) следует обязательно выключить подсветку микроскопа. При необходимости выхода из режима измерения ВФХ МДП структуры нажмите клавишу «Q». По окончании измерений на экране появится ГМ.
9. Для просмотра результатов измерения и вывода их на печать щелкните левой кнопкой мыши по клавише «График» меню первого уровня «Измерения». На экране видеомонитора появится окно «График» (рис.20) в котором представлена приведенная вольтфарадная характеристики МДП структуры  , где C0=Cmax=Ci - максимальное значение измеренной емкости МДП структуры.
, где C0=Cmax=Ci - максимальное значение измеренной емкости МДП структуры.

Справа от графика расположена таблица определенных по ВФХ параметров диэлектрика и границы диэлектрик-кремний: Cmax=Ci – максимальная емкость МДП структуры (емкость МДП структуры в режиме обогащения), Cmin – минимальная емкость МДП структуры (емкость МДП структуры в режиме сильной инверсии), Cfb – емкость плоских зон, d=di – толщина подзатворного диэлектрика, Ufb – напряжение плоских зон, Ufb-Ums – разность между напряжением плоских зон и разностью работ выхода металла и полупроводника, Nef–эффективная плотность заряда на границе полупроводник - диэлектрик, Nms – эффективная плотность заряда на границе полупроводник – диэлектрик без учета разности работ выхода, N – концентрация электрически активной донорной или акцепторной примеси в приповерхностном слое полупроводника.
Под графиком расположены две клавиши: «Выход» и «Печать». Клавиша «Печать» применяется для вывода на принтер результатов измерения. Клавишей «Выход» следует воспользоваться, если вид ВФХ или какая-либо информация не удовлетворяет измерителя.
Примечание. Клавишу «Выход» можно использовать, например, при неверном вводе площади полевого электрода, в случае неправильного выбора режима измерения ВФХ или необходимости повторного измерения ВФХ МДП.
10) Для измерения вольтфарадной характеристики другой МДП структуры на этой же пластине отройте крышку измерительной камеры, поднимите зонд, закройте кран вакуумной присоски и передвиньте столик с пластиной так, чтобы полевой электрод другой МДП структуры располагался под измерительным зондом. Откройте кран вакуумной присоски. Далее выполните действия в соответствии с пунктами 4 – 5.
11) При необходимости измерения вольтфарадных характеристик МДП структур на другой пластине отройте крышку измерительной камеры, поднимите зонд, закройте кран вакуумной присоски и выдвиньте на себя контактный стол. Уберите измеренную пластину в кассету. Достаньте из кассеты следующую пластину, установите ее на столик и передвиньте стол с пластиной так, чтобы полевой электрод измеряемой МДП структуры располагался под измерительным зондом. Откройте кран вакуумной присоски и убедитесь, что пластина с МДП структурами плотно прижата к столу. Далее по пунктам 4 – 5.
12) По окончании измерений на пластине отройте крышку измерительной камеры, поднимите зонд, закройте кран вакуумной присоски, выдвиньте стол с пластиной на себя, снимите пластину и уберите ее в кассету. Закройте кран вакуумной присоски.
13) Для просмотра и печати сохраненных в виде файлов данных результатов измерений (C-U характеристик МДП структур) служит пункт меню первого уровня «РЕЗУЛЬТАТ». После выбора клавишами «↓», «↑» и «Enter» пункта меню «РЕЗУЛЬТАТ» на экране видеомонитора появляется список сохраненных в этом каталоге файлов данных. При выборе конкретного файла клавишами «↓», «↑» и «Enter» на экране видеомонитора выводятся результаты в виде графика ВФХ C=C(U). Далее - по пункту 5.
Завершение измерений
Откройте крышку измерительной камеры, включите подсветку микроскоп и уберите пластину с МДП структурами в кассету.
Выключите блоки измерительной установки.
Пример расчета параметров МДП структуры по ее ВЧ ВФХ
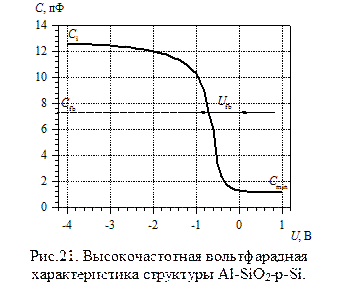 В качестве примера рассмотрим ВЧ ВФХ МДП структуры Al - SiO2 - p-Si (рис.21).
В качестве примера рассмотрим ВЧ ВФХ МДП структуры Al - SiO2 - p-Si (рис.21).
 , откуда
, откуда  при известной
при известной  или
или  при известной
при известной  .
.
 ,
,
 , откуда определяют концентрацию в подложке
, откуда определяют концентрацию в подложке  . Зная
. Зная  , вычисляют
, вычисляют  и емкость ПЗ
и емкость ПЗ  , учитывая, что
, учитывая, что  и
и  . По
. По  определяют напряжение ПЗ
определяют напряжение ПЗ  при условии
при условии  .
.
Эффективная плотность заряда  учитывает влияние всех зарядов в диэлектрике и разность работ выхода
учитывает влияние всех зарядов в диэлектрике и разность работ выхода 
Требования техники безопасности.
При выполнении работы по настоящей методике существует опасность поражения электрическим током. Для предупреждения поражения электрическим током необходимо соблюдать «Инструкцию № 26-09 по охране труда при выполнении работ на электроприборах, электроустановках в помещениях кафедры КФН».
Требования к отчету
В отчете должны быть представлены следующие материалы.
1) Краткий конспект описания с основными аналитическими зависимостями, блок-схему макета измерительной установки.
2) Графики вольтфарадных характеристик МДП структур с рассчитанными параметрами (один комплект на бригаду).
3) Перечисление источников погрешности определения параметров МДП структуры.
Контрольные вопросы
1. Измерение емкостей. Метод R-C делителя.
2. Измерение емкостей. Метод моста переменного тока.
3. Как происходит измерение ВФХ в настоящей лабораторной работе?
4. МДП структура, ее конструкция, зонная диаграмма, основные отличия реальной МДП структуры от идеальной.
5. Эквивалентная схема идеальной МДП структуры. Вольтфарадные характеристики идеальной МДП структуры и их отличия от ВФХ реальной МДП структуры.
6. ВФХ идеальной МДП структуры на n-подложке и на p-подложке. Как определить концентрацию свободных носителей заряда в подложке по ВФХ МДП структуры?
7. Режимы обогащения, обеднения, инверсии. Что такое «Напряжение плоских зон»? Какой параметр МДП структуры определяется из ее максимальной емкости?
8. Методика измерения вольтфарадных характеристик МДП структур. Что такое дифференциальная емкость? Основные параметры МДП структуры.
9. Получите формулу для максимальной толщины обедненного слоя в полупроводнике Wm. Какой параметр полупроводника может быть определен по величине минимальной емкости МДП структуры?
10. Что такое дебаевская длина? От каких параметров полупроводника она зависит?
11. Вольтфарадные характеристики МДП структуры на высоких и низких частотах.
12. Что такое эффективная плотность заряда на границе диэлектрик-кремний?
13. Объясните как из ВФХ получены параметры МДП структуры: толщина подзатворного диэлектрика, концентрация легирующей примеси в подложке, напряжение плоских зон, эффективная плотность заряда на границе диэлектрик-кремний.
14. Зависимость заряда в полупроводнике  от поверхностного потенциала
от поверхностного потенциала  .
.
15. Почему высокочастотная емкость МДП структуры в режиме инверсии не зависит от напряжения смещения?
16. Природа зарядов в диэлектрике и на границе «диэлектрик-полупроводник».
17. Методика измерения вольт – фарадных характеристик МДП структур.
18. Рассчитайте значение максимальной емкости МДП структуры, если подзатворный диэлектрик – SiO2 (εi=3.85, ε0=8.85·10-12 Ф/м) и 1) S=4·10-4 cм2, di=450 A°; 2) S=9·10-4 cм2, di=0.1 мкм; 3) S=1·10-3 cм2, di=75 нм.
19. Рассчитайте значение емкости МДП структуры в режиме плоских зон, если подзатворный диэлектрик – SiO2 (εi=3.85, ε0=8.85·10-12 Ф/м), ND=1·1016 cм-3 и 1) S=4·10-4 cм2, di=750 A° ; 2) S=9·10-4 cм2, di=0.12 мкм.
20. Рассчитайте значение минимальной емкости МДП структуры, если подзатворный диэлектрик – SiO2 (εi=3.85, ε0=8.85·10-12 Ф/м) niSi=1.2·1010 cм-3, и 1) S=1.6·10-3 cм2, di=500 A°, NA=1·1016 см-3; 2) S=1·10-3 cм2, di=75 нм, ND=1·1015 см-3; 2) S=1.6·10-3 cм2, di=0.09 мкм, ND=2·1015 см-3.
Основная литература
1. Е.С.Анфалова. Методы измерения параметров полупроводников и полупроводниковых структур. Учебное пособие. Москва 2005.
2. К.В.Шалимова. Физика полупроводников. 4-е изд., «Лань», Москва, 2010.
3. Гуртов В. А. Твердотельная электроника. 3-е изд., доп. Техносфера, Москва, 2008.
Дополнительная литература
1. С.Зи. Физика полупроводниковых приборов. В двух книгах. 1. Москва «Мир» 1984.
Продолжительность.
Работа продолжается четыре академических часа.
Оборудование, приборы, инструментарий.
Персональный компьютер с прикладным программным обеспечением, хранящимся на жестком диске; измеритель L,C,R Agilent 4284A; устройство зондовое, содержащее микроскоп МБС-9, контактный стол, два зондодержателя с зондами; форвакуумный насос Измеритель L,C,R управляется через интерфейс PCI – GPIB; кассеты с измеряемыми пластинами; пинцет. Измеритель L,C,R управляется через интерфейс PCI – GPIB
Теория.
Дата: 2019-12-10, просмотров: 391.