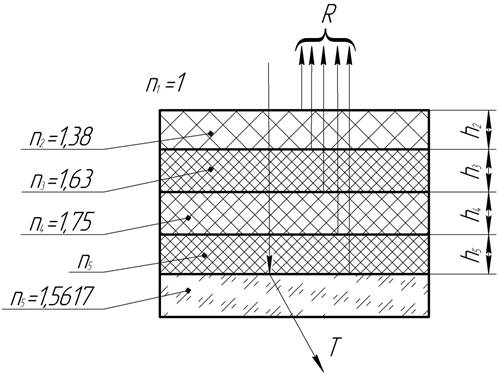
Рис. 1.10


| (1.14) |

Из таблицы плёнкообразующих материалов выбираем материал с наиболее близким показателем преломления для заданного диапазона λ1–λ2=400 – 1200 нм.
Таблица 1.10
| Пленкообразующий материал | Температура tпл/tус,°С | Методы нанесения | Показатель преломления | Область спектра λ1–λ2, мкм |
| Фтористый церий CeF3 | 1 460 800 | И, ИЭ | 1,63 | 0,3–5 |

Минимальный коэффициент отражения рассчитываем по формуле (1.11):

| (1.11) |

Для определения амплитудных и энергетических коэффициентов отражения системы воздух – пленки – подложка воспользуемся формулами (1.5) – (1.8):





 ,
,
 ,
,
 ,
,
 .
.

Для построения спектральной характеристики R 1,6 = f ( β ) и R 1,6 = f ( λ ) составим таблицы 1.5 и 1.6:
Таблица 1.11

| 0 | λ0/4 | λ0/2 | 3λ0/4 | λ0 |

| 0 | π/2 | π | 3π/2 | 2π |

| 1 | -1 | 1 | -1 | 1 |

| 0,057 | 0,014 | 0,057 | 0,014 | 0,057 |

| -0,021 | 0,005 | -0,021 | 0,005 | -0,021 |

| -0,062 | -0,034 | -0,062 | -0,034 | -0,062 |

| -0,219 | -0,127 | -0,219 | -0,127 | -0,219 |

| 0,048 | 0,016 | 0,048 | 0,016 | 0,048 |

| 0,952 | 0,9984 | 0,952 | 0,9984 | 0,952 |

Рис. 1.11
Таблица 1.12
| λ,нм | 400 | 480 | 500 | 600 | 700 | 800 | 900 | 1000 | 1100 | 1200 |

| 1,855 | 1,57 | 1,508 | 1,257 | 1,077 | 0,942 | 0,838 | 0,754 | 0,685 | 0,628 |

| -0,809 | -1 | -0,992 | -0,809 | -0,551 | -0,309 | -0,105 | 0,063 | 0,199 | 0,309 |

| 0,018 | 0,014 | 0,014 | 0,018 | 0,024 | 0,029 | 0,033 | 0,037 | 0,04 | 0,042 |

| -0,05 | -0,05 | -0,05 | -0,05 | -0,049 | -0,044 | -0,039 | -0,033 | -0,028 | -0,023 |

| -0,043 | -0,034 | -0,034 | -0,043 | -0,056 | -0,069 | -0,079 | -0,085 | -0,089 | -0,09 |

| -0,126 | -0,0128 | -0,127 | -0,126 | -0,129 | -0,139 | -0,152 | -0,165 | -0,177 | -0,187 |

| 0,016 | 0,016 | 0,016 | 0,016 | 0,017 | 0,019 | 0,023 | 0,027 | 0,031 | 0,035 |

| 0,984 | 0,984 | 0,984 | 0,984 | 0,983 | 0,981 | 0,977 | 0,973 | 0,969 | 0,965 |

Рис. 1.12
Анализ результатов
Для выбора оптимальной конструкции просветляющего покрытия построим графии спектральных зависимостей R = f (λ)для всех типов покрытий в одной системе координат.
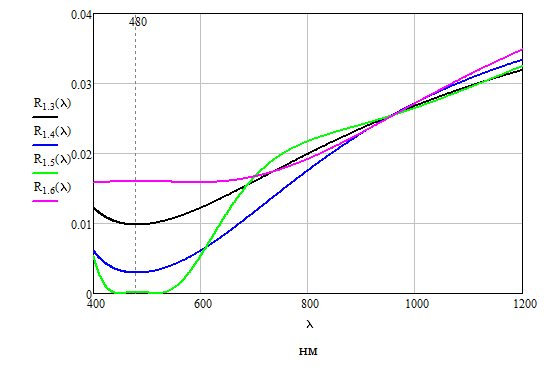
Рис. 1.13
Оптимальной является та конструкция, которая обеспечивает минимальный коэффициент отражения на рабочей длине волны λ 0 =480 нм и более широкую зону просветления в заданной области спектра.
Таким образом, оптимальным является трехслойное оптическое покрытие.
Построим графики R = f (λ) для трехслойного покрытия смоделированный и теоретический:

Рис. 1.14
Обозначим выбранную конструкцию просветляющего покрытия:
 ВД 37ИЭ 96ИЭ 24ИЭ 300 по ОСТ 3-1901-95
ВД 37ИЭ 96ИЭ 24ИЭ 300 по ОСТ 3-1901-95
λ0=480  20 нм;
20 нм;
ρ min = 0,0002
λ1–λ2=400–1200 нм;
Материал подложки: стекло БК13 ГОСТ 3514-92;
ne = 1,5617.
Вакуумная установка для нанесений покрытий ВУ–1А.
Для данной конструкции просветляющего покрытия составим технологический процесс.
Технологический процесс
010 Очистка подложек
020 Подготовка вакуумной камеры
030 Ионная очистка подложек
040 Нагрев подложек до фиксированной температуры
050 Нанесение оптического покрытия
051 Нанесение оптического покрытия PbF2
052 Нанесение оптического покрытия CeF3
053 Нанесение оптического покрытия MgF2
060 Разгерметизация вакуумной, камеры выгрузка готовых изделий
070 Контроль оптических параметров покрытий
Содержание операций:
Очистка подложек
Подложки из стекла БК – 13 ГОСТ 3514-76 обезжиривают в смеси петролейного эфира и этилового спирта в соотношении 75% - 25% и окончательно протирают тампонами обезжиренной ваты, смоченной в абсолютном этиловом спирте. Очищенные детали протирают обезжиренными батистовыми салфетками. Готовые детали вставляют в съемные оправы подложкодержателя и с их поверхностей беличьей кисточкой удаляются ворсинки. Очищенные детали в оправах загружают в подложкодержатель, и подложкодержатель устанавливается в вакуумную камеру. При выполнении этой операции оператор должен работать в резиновых перчатках или напальчниках.
020 Подготовка вакуумной камеры (происходит параллельно с операцией 010)
· очистка элементов подколпачной аппаратуры (экранов, испарителей, заслонов) от пленок испаряемых материалов и пропитку их спиртом
· загрузка исходных пленкообразующих материалов в испарители
(MgF2, CeF3 и PbF2 в виде таблеток в 3х позиционный тигель электронно-
лучевого испарителя - ЭЛИ)
· загрузка подложкодержателя с очищенными оптическими деталями
· проверка работоспособности механизмов и устройств вакуумной камеры; вращение подложкодержателя, перемещение заслонок, работа фотометра
· откачка камеры до давления примерно 2 Па.
Ионная очистка подложек
Операция проводится в камере (P=2...1,38 Па) в течение 5–10 минут при напряжении 500 В на электроде ионной очистки и токе разряда 150–200 мА. При этом включается вращение подложкодержателя с частотой n =10–20 мин-1. В процессе ионной очистки ионами остаточных газов с поверхности удаляются пылинки и молекулы тяжелых газов. По окончании ионной очистки камера откачивается до Р =10-2 –10-3 Па.
Дата: 2018-12-21, просмотров: 479.