Оборудование и технология проведения эпитаксии.
Рассмотрим упрощенную схему установки для получения эпитаксиальных слоев на кремнии с использованием газофазовых реакций.
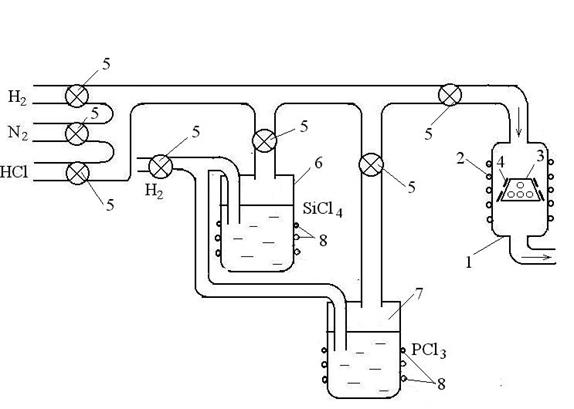
1 – кварцевый реактор,
2 – индуктор,
3 – подложкодержатель,
4 – полупроводниковые пластины,
5 – вентиль для закрытия/открытия газовых магистралей,
6 – барботёр,
7 – барботёр с диффузантом,
8 – нагреватели, необходимые для задания и поддержания температурного режима в барботёре.
Рассмотрим простейший цикл работы установки.
1. загрузка полупроводниковых пластин в реактор, герметизация реактора.
2. Вытеснение воздуха из реактора с помощью водорода, затем нагрев пластин
3. Подача в реактор газообразного HCl
4. Охлаждение полупроводниковых пластин
5. Подача в реактор паров тетрахлорида кремния, паров диффузанта и водорода.
6. Отключение паров тетрахлорида кремния и охлаждение полупроводниковых пластин
7. Разгерметизация реактора и выгрузка полупроводниковых пластин.
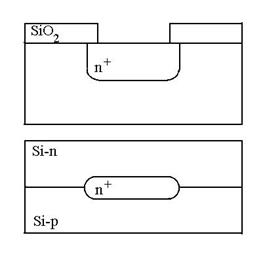
Таким образом, формируется скрытый диффузионный слой.
Сухое, влажное и смешанное окисление кремния и оборудование для проведения процесса в технологии ИМС.
В технологии микро- и наноэлектроники для получения термических пленок диоксида кремния в качестве оборудования обычно используются диффузионные печи
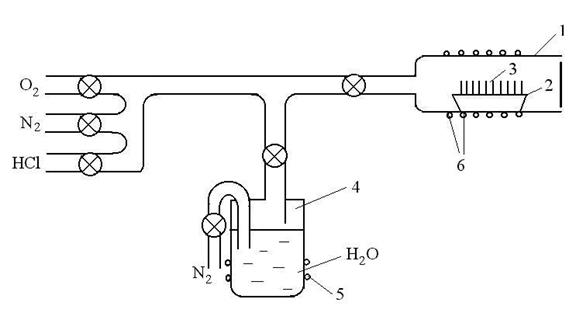
Схема печи:
1.- кварцевая труба,2. - кварцевая лодочка,3. - полупроводниковые пластины,4. - барботёр
5. - нагреватель барботера6.– нагреватель кварцевой трубы
7. -где крестики,то блять клапаны называется
1. Сухое окисление. Термическая пленка SiO2 формируется в результате взаимодействия поверхности кремния с газообразным кислородом. Данный вид окисления обладает низкой скоростью окисления и высокой энергией активации процесса (1,3 – 1,4 эВ).
2. Влажное окисление. Реализуется в парах воды. Поскольку молекулы воды имеют меньший диаметр по сравнению с молекулами кислорода, то скорость роста влажной пленки существенно превосходит скорость роста пленки при сухом окислении. Энергия активации: 0,7 эВ.
3. Смешанное окисление. Термическую пленку диоксида кремния формируют путем одновременной подачи в канал как газообразного кислорода, так и паров воды. При смешанном окислении меняя процентное содержание между кислородом и парами, можно формировать окислы с параметрами от сухого до влажного..
Проекционная фотолитография
В данном виде фотолитографии используются фотошаблоны, на которых топологические элементы в 4 или 10 раз больше реальных размеров, которые необходимо получить на полупроводниковой пластине. Между таким фотошаблоном и полупроводниковой пластиной размещается проекционная оптика, которая уменьшает изображение с фотошаблона до реальной величины. В проекционной фотолитографии осуществляется пошаговое экспонирование одного или нескольких кристаллов на полупроводниковую пластину.
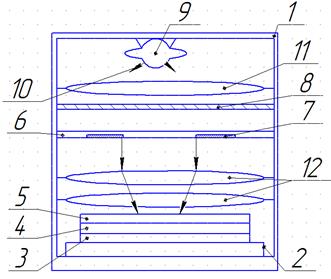
1. Основание установки
2. Подвижный столик
3. Полупроводниковая пластина
4. Пленка на поверхности п/п пластины, по которой проводится фотолитография
5. Фоторезист
6. Фотошаблон проекционный
7. Пленка на фотошаблоне, непрозрачная для ультрафиолета
8. Электромагнитный затвор
9. источник УФ-излучения
10. УФ-лучи
11. оптический конденсатор
12. Проекционная система
Проекционная фотолитография обладает более низкой производительностью по сравнению с контактной, однако она позволяет существенно повысить точность передачи изображения.
Установки ионного легирования.

1. – Герметичный корпус установки
2. Ионизационная камера
3. Вытягивающий электрод
4. Пучок ионов
5. Электромагнитная линза
6. Каскадный ускоритель
7. Корректирующие пластины
8. Диафрагма
9. Электромагнитный сепаратор
10. Сканирующая система
11. Полупроводниковая пластина
12. Столик, на котором закреплена пластина
13. Устройство откачки
После загрузки полупроводниковых пластин осуществляется герметизация установки и создание внутри корпуса глубокого вакуума за счет устройства откачки. Затем в ионизационной камере легирующая примесь переводится в газообразное или парообразное состояние, после чего ионизируется. Пучок ионов вытягивается из ионизационной камеры с помощью потенциала. С помощью электромагнитной линзы осуществляется фокусировка ионного пучка. Затем с использованием каскадного ускорителя ионный пучок ускоряется до требуемой энергии. Корректирующие пластины направляют ускоренный ионный пучок в электромагнитный сепаратор. В электромагнитном сепараторе происходит разделение ионного пучка по атомной массе элементов. В результате на выходе сепаратора получаем только ускоренный пучок ионов легирующей примеси.
5.Физико-химические основы ионной имплантации(теор. описание)
При ионной имплантации примеси в полупроводник могут наблюдаться следующие два случая прохождения ионов. Пучок 1-й получил название неканалированный.
Неканалированный пучок используется для тонкого легирования.

Для каналированного пучка 2 потери энергии ионов происходят в результате его взаимодействия с электронными оболочками атомов в междоузельном пространстве
Для определения профиля распределения имплантированной примеси введем следующее обозначение
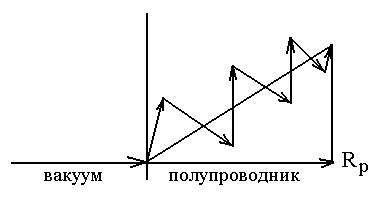
Rp – проекция на ось, совпадающую с первоначальным направлением пучка
Тогда профиль распределения примеси можно записать в следующем виде:

 [Кл/см2]
[Кл/см2]
График профилей распределения имплантируемых примесей с различной энергией ионов

После ионного внедрения примеси, необходимо провести термический отжиг при температурах выше 8500С.
Ионное легирование используют для загонки примесей, а затем путем термической диффузии формируют окончательный профиль PN-перехода.
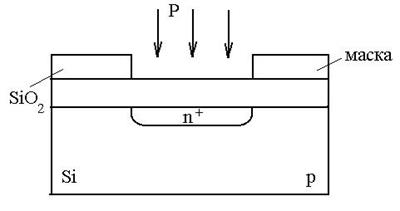
6. Физико-химические основы эпитаксии
Эпитаксиальным наращиванием называется процесс направленного наращивания слоя монокристалла на полупроводниковой или изолирующей подложке.
Гетероэпитаксией - это направленное наращивание пленки материала.
Используется при работе с полупроводниковыми
. 
Эпитаксию в основном используют для формирования PN-переходов, также дает возможность формировать изотипный переход.

В технологии МНЭ различают газофазовую эпитаксию, жидкофазовую эпитаксию и твердофазовую эпитаксию. В кремниевой технологии применяется газофазовая эпитаксия. При реализации газофазовой эпитаксии в основном используется два типа химических реакций: реакция восстановления и реакция разложения.
Жидкофазовая используется ждя формирования гетероперехода
Дата: 2019-03-05, просмотров: 494.