InSb-InSbBi
Волгодонский институт ЮРГТУ (НПИ), г. Волгодонск, ул. Ленина 73/94, тел.: 25668
Анализ физических свойств гетеропереходов, проведенный нами для
гетероструктур InSbBi/InSb, показал, что причиной возможной деградации
частотных характеристик и добротности фотодетекторов с использованием этих
твердых растворов могут быть скачки в зонной структуре гетероперехода.
Эффективность гетероперехода со скачком потенциала в валентной зоне на
гетерогранице ∆Е пропорциональна exp ( ∆Е/kT), где
∆Е = Еg1 - Еg2 - ∆Е0
Захват носителей приводит к замедлению релаксации фототока с постоянной
времени τ ~ exp( ∆Е / kT) ≥ 10 нс, что существенно снижает быстродействие
фотоприемников. Значение ∆Е для гетероперехода InSb0.98Bi0.02/InSb составляет
около 0,05 эВ.
Сглаживание гетеропереходов достигается применением буферных слоев
постоянного или переменного по толщине состава[1]. Оптимальным вариантом
здесь могут оказаться сверхрешеточные структуры, варизонность которых
сохраняется на больших длинах ~ 1,5 мкм.
Для реализации этой задачи нами были получены с помощью методики[2]
двойные гетероструктуры InSb – InSbBi.
Согласно[3], рост Bi-содержащих твердых растворов может происходить как
автоволновый концентрационный процесс в условиях потери устойчивости фронтом
кристаллизации. Нами был получен ряд образцов, состоящих из чередующихся
слоев InSb и InSb0.985Bi0.015. Перекристаллизация осуществлялась при Т = 693 К, grad
T = 30 К/cм движением плоской жидкой зоны усредненного состава In0.45Bi0.55 со
скоростью (65XXX 10) мкм/час. Общая толщина эпитаксиальной пленки InSb-InSbBi
составляла около 5,5 мкм. На рис. 1 приводится электронная микрофотография
поверхности выращенных образцов. Как отдельные слои, так и структура в целом
обладают высокой планарностью, толщины разных слоев близки. Слои InSb,
чередующиеся со слоями InSbBi, образуют правильную периодическую структуру с
периодом TSL = 120 нм.
Центр эпитаксиальной структуры либо свободен от дислокаций
несоответствия, либо содержит их незначительное количество. Измерение
удельного сопротивлениячетырехзон-довым методом показало, что концентрация
висмута по диаметру эпитаксиальных структур не изменялась. Поэтому можно
считать, что увеличение плотности дислокаций несоответствия связано с
радиальными градиентами в процессе роста структур, что обуславливает градации
интенсивности на электронной микрофотографии.

Рис. 1. Электронная микрофотография поверхности гетероструктуры
InSb – InSb 0.985 Bi 0.015 – .20000.
Измерения, проведенные на основе рентгенографических исследований,
показали, что суммарная толщина пары слоев InSb и InSbBi
d1 + d2 ≈ 120 нм.
Ширина запрещенной зоны в такой сверхрешетке при переходе от слоя к слою
модулируется по закону:
Eg(x) = (Eg1d1 + Eg2d2 )/(d1 + d2)
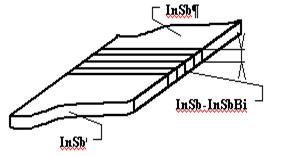
Рис. 2. Схема лавинного фотодиода на основе сверхрешетки InSb-InSbBi
При этом снимается проблема программированного изменения состава
твердого раствора на малых длинах (~ 0,1 мкм). Градиентный слой уменьшает
величину скачка в валентной зоне так, что ∆Е → 0 и длинновременная
составляющая релаксации фототока τp → 0. Быстродействие при этом может
сокращаться до значений ~ 1 нс. Структура такого лавинного фотодиода
представлена на рис. 2. Топологически такой прибор приводится к структуре
фотоприемника с растровыми электродами, изоляция между которыми выполнена
обратносмещенными p-n-переходами.
Таким образом, в технологии фотоприемных устройств инфракрасного
диапазона (спектры фотолюминесценции имеют максимум вблизи 8,7 мкм) могут
быть перспективны структуры типа «квантовой ямы».
Принципиальная схема
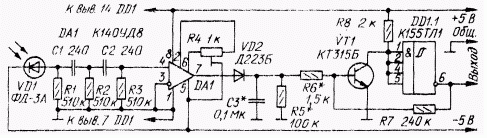
Фоторезисторы
Фоторезисторами называют полупроводниковые приборы, проводимость которых меняется под действием света.
Конструкция монокристаллического и пленочного фоторезисторов показана на рис. 1, 2 приложения. Основным элементом фоторезистора является в первом случае монокристалл, а во втором – тонкая пленка полупроводникового материала.
Если фоторезистор включен последовательно с источником напряжения (рис. 3 приложения) и не освещен, то в его цепи будет протекать темновой ток
Iт = E / (Rт + Rн), (4)
где Е – э. д. с. источника питания; Rт – величина электрического сопротивления фоторезистора в темноте, называемая темновым сопротивлением; Rн – сопротивление нагрузки.
При освещении фоторезистора энергия фотонов расходуется на перевод электронов в зону проводимости. Количество свободных электронно-дырочных пар возрастает, сопротивление фоторезистора падает и через него течет световой ток
Iс = E / (Rс + Rн). (5)
Разность между световым и темновым током дает значение тока Iф, получившего название первичного фототока проводимости
Iф = Iс – Iт. (6)
Когда лучистый поток мал, первичный фототок проводимости практически безынерционен и изменяется прямо пропорционально величине лучистого потока, падающего на фоторезистор. По мере возрастания величины лучистого потока увеличивается число электронов проводимости. Двигаясь внутри вещества, электроны сталкиваются с атомами, ионизируют их и создают дополнительный поток электрических зарядов, получивший название вторичного фототока проводимости. Увеличение числа ионизированных атомов тормозит движение электронов проводимости.
В результате этого изменения фототока запаздывают во времени относительно изменений светового потока, что определяет некоторую инерционность фоторезистора.

Дата: 2019-12-10, просмотров: 373.